Трехэлектродная система распыления
Для повышения чистоты получаемой на подложке пленки процесс ионно-плазменного распыления необходимо проводить при как можно меньшем давлении рабочего газа. Однако, как уже отмечалось ранее, понижение давления приводит к тому, что при большой длине свободного пробега электронов вероятность их столкновения с атомами рабочего газа становится ничтожно малой, и газовый разряд гаснет. Поэтому для поддержания разряда в камере и обеспечения распыления мишени при низких давлениях необходимы специальные меры.
Одним из вариантов решения проблемы является применение трехэлектродной системы распыления, изображенной на рис. 4.8. Цифрами на рисунке обозначены: 1 – термокатод; 2 – анод; 3 – мишень; 4 – подложка; 5 – подложкодержатель. Таким образом, в данной системе имеются три независимо управляемых электрода: термокатод, анод и распыляемая мишень, потенциал которой относительно термокатода составляет несколько киловольт.
 По достижении в камере вакуума порядка 10-4 Па термокатод разогревают и в камеру через натекатель подают инертный газ при давлении 0,05 - 1 Па. В результате термоэлектронной эмиссии с катода будут интенсивно испускаться электроны, ускоряющиеся вертикальным электрическим полем. При напряжении между термокатодом и анодом порядка 100 В возникает несамостоятельный газовый разряд, при этом разрядный ток достигает нескольких ампер. Мишень, имеющая отрицательный потенциал относительно катода, оттягивает на себя значительную часть ионов, образующихся в газовом разряде, и ускоряет их. В результате бомбардировки мишени ионами происходит ее распыление, и распыленные атомы осаждаются на подложке, формируя тонкую пленку.
По достижении в камере вакуума порядка 10-4 Па термокатод разогревают и в камеру через натекатель подают инертный газ при давлении 0,05 - 1 Па. В результате термоэлектронной эмиссии с катода будут интенсивно испускаться электроны, ускоряющиеся вертикальным электрическим полем. При напряжении между термокатодом и анодом порядка 100 В возникает несамостоятельный газовый разряд, при этом разрядный ток достигает нескольких ампер. Мишень, имеющая отрицательный потенциал относительно катода, оттягивает на себя значительную часть ионов, образующихся в газовом разряде, и ускоряет их. В результате бомбардировки мишени ионами происходит ее распыление, и распыленные атомы осаждаются на подложке, формируя тонкую пленку.
|
|
|
Такие трехэлектродные системы, в которых электрические цепи разряда и распыления разделены и управляются независимо друг от друга, обеспечивают гибкость управления процессом. Скорость осаждения составляет единицы нанометров в секунду, что в несколько раз превышает аналогичный показатель для двухэлектродной схемы катодного распыления.
Дальнейшее развитие трехэлектродных систем распыления привело к использованию автономных ионных источников. Ионный источник представляет собой газоразрядную камеру с термокатодом, в которую подается рабочий газ под давлением ~ 0,5 Па, что обеспечивает высокую концентрацию ионов. Газоразрядная камера отделена от камеры осаждения калиброванными отверстиями, благодаря чему обеспечивается перепад давлений, и давление в камере осаждения, где расположены мишень и подложка, составляет ~ 0,015 Па. Часть ионов поступает через отверстия в камеру осаждения, ускоряется и распыляет мишень. Такая конструкция позволяет увеличить скорость распыления мишени и повысить чистоту осаждаемых на подложке пленок.
|
|
|
Высокочастотное распыление
Рассмотренные выше методы получения тонких пленок используют постоянные напряжения, прикладываемые к электродам системы распыления мишени. Это позволяет распылять мишени только из электропроводящих или полупроводниковых материалов. Если мишень выполнена из диэлектрика, то при ее бомбардировке положительно заряженными ионами на ней очень быстро будет накапливаться положительный заряд. Этот заряд создаст электрическое поле, которое будет тормозить бомбардирующие мишень ионы. Распыление мишени очень быстро прекратится.
Для распыления диэлектрической мишени необходимо между анодом и катодом-мишенью подавать переменное напряжение. В этом случае мишень поочередно будет обрабатываться потоками электронов и положительно заряженных ионов. При отрицательном потенциале на мишени будет происходить ее распыление ионами, а при положительном потенциале –нейтрализация заряда потоком электронов. Это в принципе позволяет распылять мишени из диэлектрических материалов, однако эффективность такого метода распыления будет невысокой.
|
|
|
Эффективность распыления можно значительно повысить, если между анодом и катодом-мишенью подать переменное напряжение частотой порядка 10 МГц (обычно используют частоту 13,56 МГц, разрешенную для технологических установок, работающих в этом частотном диапазоне). Повышение эффективности при высокочастотном распылении объясняется следующим образом. Масса электронов значительно меньше массы ионов. Поэтому, обладая значительно большей подвижностью, электроны успевают следовать за быстроменяющимся полем, переходя с одного электрода на другой. Ионы, будучи гораздо менее подвижными, не успевают заметно перемещаться в межэлектродном пространстве, в результате чего там образуется объемный положительный заряд ионов. Кроме того, количество электронов, поступающих на мишень за полпериода, значительно превышает то количество, которое необходимо для нейтрализации заряда ионов на мишени. В результате на диэлектрической мишени скапливается отрицательный заряд электронов. Все это приводит к появлению в межэлектродном пространстве дополнительного электрического поля, которое способно ускорить часть ионов до больших энергий, что и увеличивает эффективность распыления мишени.
|
|
|
 |
Следует отметить еще одно важное обстоятельство. В условиях высокочастотного разряда заряженные частицы (электроны и ионы) совершают колебательное движение с амплитудой А, равной
где m - подвижность частицы, зависящая от давления газа; Е0 – амплитуда напряженности переменного электрического поля; w - циклическая частота питающего напряжения.
Если расстояние между электродами превышает амплитуду А, то на электроды поступают только те частицы, которые находятся от электрода на расстоянии, не превышающем А. При этом существенно, что в средней части разряда электроны совершают осциллирующие движения, эффективно ионизируя газ, поэтому высокочастотный разряд может существовать при более низких давлениях, и надобность в сложной трехэлектродной системы отпадает. Благодаря пониженному давлению в газоразрядной камере, высокочастотные системы с успехом используют для распыления не только диэлектрических мишеней, но и мишеней из металлов и полупроводников.
Реактивное распыление
При реактивном распылении в газоразрядную камеру наряду с рабочим газом (обычно аргоном) добавляется небольшое количество реакционного активного газа (кислорода, азота и др.), в результате чего на подложке образуется пленка из химического соединения, образованного атомами мишени и активного газа. Если, например, мишень изготовлена из алюминия, а в качестве активного газа используется кислород, то на подложке получается пленка из оксида алюминия, если же в камеру добавляется азот, то получится пленка из нитрида алюминия.
Кроме оксидных и нитридных пленок, данным способом можно получать карбидные и сульфидные пленки, добавляя в камеру соответственно метан СН4 или пары серы. Для получения химического соединения необходимо строго определенное парциальное давление активного газа, зависящее от материала мишени. Поэтому чаще получаются не химические соединения, а твердые растворы. На основе одной мишени из какого-либо металла и различных активных газов можно получать широкую гамму свойств осаждаемых пленок – от проводящих и низкоомных резистивных до высокоомных резистивных и диэлектрических.
Использовать реактивное распыление взамен непосредственного распыления мишени из химического соединения целесообразно тогда, когда коэффициент распыления данного химического соединения (оксида, нитрида и так далее) низкий, либо тогда, когда технологически трудно изготовить массивную мишень из этого соединения. Кроме того, реактивное распыление создает условия для гибкого управления свойствами пленок при создании многослойных структур (например, пленочных конденсаторов).
В общем случае процесс осаждения пленок при реактивном распылении обусловлен тремя механизмами, действующими параллельно:
- образование химического соединения на поверхности мишени и его распыление;
- образование химического соединения в пролетном пространстве «мишень - подложка» и осаждение его на подложку;
- взаимодействие осажденных на подложке атомов мишени с атомами активного газа.
В условиях невысокого давления газа в камере вероятность второго механизма весьма мала и его вклад в общий процесс формирования пленки на подложке незначителен. Что касается соотношения вкладов первого и второго механизмов, то это зависит от условий распыления, а именно, от рода материала мишени и от рода активного газа, от общего давления газовой смеси в камере и от парциального давления активного газа; от расстояния между мишенью и подложкой. На практике часто уменьшение давления парциального газа при прочих равных условиях увеличивает вероятность образования соединения непосредственно на подложке. В большинстве случаев необходимые реакции полностью протекают при содержании активного газа в газовой смеси (аргон + активный газ) порядка единиц процентов.
Магнетронное распыление
Стремление снизить давление рабочего газа в камере и увеличить скорость распыления мишеней привело к созданию метода магнетронного распыления. Один из возможных вариантов схем магнетронного распылителя представлен на рис. 4.9. Цифрами обозначены: 1 – мишень, одновременно являющаяся катодом распылительной системы; 2 – постоянный магнит, создающий магнитное поле, силовые линии которого параллельны поверхности мишени; 3 – кольцевой анод. Выше анода располагается подложка (на рисунке не показана), на которой формируется пленка из материала мишени.
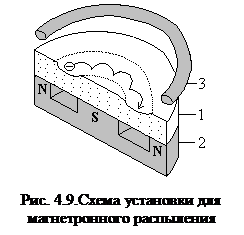 Отличительной особенностью магнетронного распылителя является наличие двух скрещенных полей – электрического и магнитного. Если из мишени-катода будет испускаться электрон (за счет вторичной электронной эмиссии), то траектория его движения будет определяться действием на него этих полей. Под воздействием электрического поля электрон начнет двигаться к аноду. Действие магнитного поля на движущийся заряд приведет к возникновению силы Лоренца, направленной перпендикулярно скорости. Суммарное действие этих сил приведет к тому, что в результате электрон будет двигаться параллельно поверхности мишени по сложной замкнутой траектории, близкой к циклоиде.
Отличительной особенностью магнетронного распылителя является наличие двух скрещенных полей – электрического и магнитного. Если из мишени-катода будет испускаться электрон (за счет вторичной электронной эмиссии), то траектория его движения будет определяться действием на него этих полей. Под воздействием электрического поля электрон начнет двигаться к аноду. Действие магнитного поля на движущийся заряд приведет к возникновению силы Лоренца, направленной перпендикулярно скорости. Суммарное действие этих сил приведет к тому, что в результате электрон будет двигаться параллельно поверхности мишени по сложной замкнутой траектории, близкой к циклоиде.
Важным здесь является то, что траектория движения замкнутая. Электрон будут двигаться по ней до тех пор, пока не произойдет несколько столкновений его с атомами рабочего газа, в результате которых произойдет их ионизация, а сам электрон, потеряв скорость, переместиться за счет диффузии к аноду. Таким образом, замкнутый характер траектории движения электрона резко увеличивает вероятность его столкновения с атомами рабочего газа. Это означает, что газоразрядная плазма может образовываться при значительно более низких давлениях, чем в методе катодного распыления. Значит и пленки, полученные методом магнетронного распыления, будут более чистыми.
Другое важное преимущество магнетронных систем обусловлено тем, что ионизация газа происходит непосредственно вблизи поверхности мишени. Газоразрядная плазма локализована вблизи мишени, а не «размазана» в межэлектродном пространстве, как в методе катодного распыления. В результате резко возрастает интенсивность бомбардировки мишени ионами рабочего газа, тем самым увеличивается скорость распыления мишени и, как следствие, скорость роста пленки на подложке (скорость достигает несколько десятков нм/с).
Наличие магнитного поля не дает электронам, обладающим высокой скоростью, долететь до подложки, не столкнувшись с атомами рабочего газа. Поэтому подложка не нагревается вследствие бомбардировки ее вторичными электронами. Основным источником нагрева подложки является энергия, выделяемая при торможении и конденсации осаждаемых атомов вещества мишени, в результате чего температура подложки не превышает 100 - 200 °С. Это дает возможность напылять пленки на подложки из материалов с малой термостойкостью (пластики, полимеры, оргстекло и так далее).
4.3. Технология толстопленочных ГИС
Сущность технологического процесса
Технология производства толстопленочных гибридных интегральных микросхем базируется на формировании на поверхности диэлектрической подложки «толстых» (толщиной более десяти микрометров) слоев различных материалов, которые выполняют функции проводящих дорожек, контактных площадок, резисторов, конденсаторов и так далее. Слои наносят в виде паст различного состава через специальные трафареты. После нанесения слоев производится термическая обработка (сушка и вжигание) для придания им заданных электрофизических и механических свойств. Обычно на подложке требуется формировать различные элементы ГИС (проводники, резисторы, конденсаторы), поэтому совокупность операций, включающая в себя нанесение слоя через трафарет и его термическую обработку, многократно повторяется. При этом для каждого топологического слоя требуется свой трафарет и своя паста.
Поскольку температура вжигания для электропроводящих, резистивных и диэлектрических паст различна, то последовательность нанесения слоев должна быть вполне определенной. Сначала наносится электропроводящая паста, образующая проводники, контактные площадки и нижние обкладки конденсаторов, затем паста для диэлектриков конденсаторов и изоляции возможных пересечений проводников. Третьим слоем наносятся верхние обкладки конденсаторов и пересекающиеся проводники. Наконец, наносятся резистивные пасты, причем вначале наносятся пасты, имеющие наибольшую температуру вжигания, а в конце – пасты с наименьшей температурой вжигания. Разумеется, последовательность операций может быть и иной, но важно, чтобы термическая обработка каждого последующего слоя не влияла на свойства уже нанесенных на подложку слоев.
Качество толстопленочных элементов ГИС в основном хуже, чем у тонкопленочных элементов, полученных термовакуумным испарением или ионно-плазменными методами. Это касается, в первую очередь, величины ТКС резисторов и ТКЕ конденсаторов, временной стабильности и технологического разброса параметров. Однако у толстопленочной технологии есть существенное преимущество перед тонкопленочной технологией – она намного проще и экономичнее.
Подложки для толстопленочных ГИС должны соответствовать определенным требованиям. Материал подложки должен иметь высокое объемное и поверхностное удельное сопротивления, низкие диэлектрические потери и высокую теплопроводность. Подложки должен быть механически прочным и хорошо обрабатываться. Они должны быть достаточно термостойкими и должны обеспечивать хорошую адгезию наносимых на них паст. Наибольшее распространение получили подложки из керамики на основе оксида алюминия.
Состав паст
Пасты включают в себя три составляющие: функциональная составляющая; конструкционная составляющая (постоянное связующее) и технологическая составляющая (временное связующее). Функциональная составляющая представляет собой мелкодисперсные частицы неорганических веществ (металлов, оксидов металлов и солей), которые определяют основные свойства элементов ГИС (проводников, резисторов, конденсаторов и так далее).
Конструкционная составляющая – это мелкодисперсные частицы стекла (стеклянная фритта), температура плавления которого ниже температуры вжигания. В частности, широко используются свинцовоборосиликатные стекла с температурой плавления менее 600 °С. В процессе вжигания расплавленное стекло смачивает частицы функциональной фазы, образуя суспензию, а после охлаждения и затвердевания образуется механически прочное покрытие с квазиравномерным распределением частиц функциональной фазы.
Технологическая составляющая играет роль временной технологической связки, придающей пасте определенную вязкость и пластичность. Эта составляющая содержит органические вещества (ланолин, канифоль и другие), в которые добавляется растворитель. Растворитель впоследствии испаряется в процессе сушки, а органическое вещество разлагается или сгорает при вжигании и полностью удаляется.
В зависимости от назначения все пасты делятся на проводниковые, резистивные и диэлектрические. Функциональной фазой проводниковых паст является мелкодисперсный порошок (размер частиц порядка единиц микрометров) благородных металлов (Ag, Pd, Au), обладающих высокой проводимостью, химической стойкостью и особыми технологическими свойствами, например способностью к сварке и пайке. Обычно соотношение функциональной составляющей и стеклянной фритты примерно равно 9:1. При таком соотношении компонентов возможен массовый взаимный контакт металлических частиц. Сопротивление таких паст относительно невелико и из них можно формировать проводящие дорожки гибридной микросхемы. С целью снижения стоимости предпринимаются попытки использовать другие более дешевые компоненты функциональной фазы (Cu, Al, Ni), однако свойства получаемых элементов значительно хуже, а технологический процесс (в первую очередь операция вжигания) существенно сложнее.
Резистивные пасты включают в себя в качестве функциональной фазы мелкодисперсные частицы металла (Pd, Ag, W) и оксидов металлов. Частицы оксидов металлов, обладающие изолирующими и полупроводниковыми свойствами, разобщают частицы металла, в результате чего образуются проводящие цепочки, сопротивление которых зависит от соотношения частиц металла и оксида металла. Варьируя соотношение компонент функциональной фазы и стеклянной фритты, можно получить требуемое удельное сопротивление резистивного слоя. Широкое применение находят серебряно-палладиевые резистивные пасты, функциональной основой которых является палладий и оксид серебра. К недостаткам серебряно-палладиевых резистивных паст следует отнести высокую чувствительность к режимам термообработки и относительно низкую стабильность параметров получаемых резисторов. Для получения прецизионных резисторов используют пасты на основе оксида рутения RuO2 с добавками оксидов других металлов. Ограниченное применение находят пасты на основе оксида индия, отличающиеся невысокой стабильностью параметров.
Диэлектрические пасты бывают двух видов: для диэлектриков в конденсаторных структурах и для межслойной изоляции. Для конденсаторов обычно используют пасты, функциональной составляющей в которых служит порошок из сегнетоэлектриков (например, титанат бария BaTiO3), имеющих высокие значения диэлектрической проницаемости. Для межслойной изоляции используют пасты на основе различных стекол.
Дата добавления: 2018-05-12; просмотров: 744; Мы поможем в написании вашей работы! |

Мы поможем в написании ваших работ!
