Влияние плотности потока и температуры подложки
На структуру и свойства осаждаемых пленок
Третьей стадией процесса напыления тонких пленок является стадия конденсации атомов и молекул вещества на поверхности подложки. Эту стадию условно можно разбить на два этапа: начальный этап – от момента адсорбции первых атомов (молекул) на подложку до момента образования сплошного покрытия, и завершающий этап, на котором происходит гомогенный рост пленки до заданной толщины.
Условия, в которых протекает начальный этап, имеют определяющее значение для структуры полученной пленки, прочности ее сцепления с подложкой, времени формирования пленки. Поэтому изучение явлений, происходящих на подложке в начальный период, имеет большое практическое значение. Поскольку математическое описание явлений, сопровождающих начальный этап формирования пленки, носит приближенный и неполный характер, рассмотрим лишь качественную картину этих явлений.
Атомы испаренного вещества подлетают к подложке с довольно большой скоростью порядка сотен и тысяч метров в секунду. При столкновении с подложкой атом передает ей часть энергии, причем доля этой энергии тем меньше, чем выше температура подложки. Обладая некоторым избытком энергии, атом вещества некоторое время мигрирует по поверхности подложки, теряя постепенно энергию и стремясь к тепловому равновесию с подложкой, то есть переходит в адсорбированное состояние.
|
|
|
При отсутствии химического взаимодействия атомов вещества с материалом подложки (физическая адсорбция) энергия связи определяется силами Ван-дер-Ваальса и имеет значение порядка 0,01 - 0,1 эВ. В зависимости от потенциального рельефа, образованного поверхностными атомами подложки, адсорбированный атом может, потеряв значительную часть избыточной энергии, закрепиться на подложке (сконденсироваться). Однако вероятность такого процесса для одиночного атома очень невелика. Значительный избыток энергии адсорбированного атома и длительная миграция по подложке приводят к тому, что он с большой вероятностью десорбируется (реиспарится), то есть покинет поверхность подложки. Если подложка нагрета, а плотность атомного потока небольшая, практически исключающая взаимодействие атомов вещества на подложке, то наступает равновесное состояние, при котором поток падающих на поверхность атомов равен потоку десорбированных атомов. Конденсации вещества на подложке при этом практически не происходит.
Конденсация вещества может начаться при пересыщении пара на подложке. Если плотность потока высока или температура подложки низка, то вероятность вторичного испарения уменьшается, а вероятность встречи атомов друг с другом на подложке увеличивается. При этом образуются атомные группы, более устойчивые к повторному испарению, так как кинетическая энергия адсорбированных атомов частично переходит в потенциальную энергию их взаимодействия. Такая группа может стать зародышем пленки, если ее размер превышает некоторый критический, при котором вероятность конденсации (окончательного закрепления на подложке) превышает вероятность распада группы на отдельные атомы. Схематически этот процесс показан на рис. 4.3.
|
|
|
 |
Дальнейший рост зародышей происходит за счет присоединения к ним вновь адсорбированных атомов, а также за счет непосредственного осаждения атомов на поверхность зародыша. Разрастаясь, отдельные островки-зародыши сливаются, постепенно образуя сплошную пленку. На завершающем этапе, когда сформирована сплошная пленка, ее рост носит гомогенный характер. Влияние подложки при этом отсутствует, а характер связи (металлическая, ковалентная) падающих на поверхность атомов определяется веществом пленки.
Таким образом, структура полученной пленки определяется размерами зародышей, образовавшихся на начальном этапе конденсации. При высоких температурах подложки размеры критических зародышей больше и пленка получается крупнозернистой. При низких температурах подложки пленка получается мелкозернистой. На структуру пленки также влияет и плотность потока атомов. При увеличении плотности потока размеры критических зародышей уменьшаются, количество центров зародышеобразования увеличивается, в результате пленка получается мелкозернистой. Уменьшение плотности потока приводит к увеличению зернистости пленки. При фиксированной плотности потока существует критическая температура подложки, выше которой пленка на поверхности подложки не образуется. И, наоборот, при фиксированной температуре подложки существует критическая плотность потока атомов, ниже которой пленка не образуется.
|
|
|
Какая из структур (крупнозернистая или мелкозернистая) лучше - определяется конкретным назначением пленки. Если, например, она предназначена для формирования пленочных резисторов, то лучше крупнозернистая структура, поскольку она более стабильна при колебаниях температуры в процессе эксплуатации данных резисторов. Мелкозернистая структура при повышенных температурах эксплуатации резисторов подвержена влиянию процессов рекристаллизации, приводящих к изменению электрофизических свойств пленки. Если, например, требуется получить высококачественные зеркала, то в этом случае желательно формировать мелкозернистую пленку.
|
|
|
4.2. Ионно-плазменные методы получения тонких пленок
Ионно-плазменные методы получили широкое распространение в технологии электронных средств благодаря своей универсальности и ряду преимуществ по сравнению с другими технологическими методами. Универсальность определяется тем, что с их помощью можно осуществлять различные технологические операции: формировать тонкие пленки на поверхности подложки, травить поверхность подложки с целью создания на ней заданного рисунка интегральной микросхемы, осуществлять очистку поверхности. К преимуществу ионно-плазменных методов относится высокая управляемость процессом; возможность получения пленок тугоплавких материалов, а также химических соединений и сплавов заданного состава; лучшая адгезия пленок к поверхности и так далее.
Суть методов ионно-плазменного напыления тонких пленок заключается в обработке поверхности мишени из нужного вещества ионами и выбивании атомов (молекул) из мишени. Энергия ионов при этом составляет величину порядка сотен и тысяч электрон-вольт. Образующийся атомный поток направляется на подложку, где происходит конденсация вещества и формируется пленка. Различают ионно-лучевое распыление, осуществляемое бомбардировкой мишени пучком ускоренных ионов, сформированным в автономном ионном источнике, и собственно ионно-плазменное распыление, при котором мишень является одним из электродов в газоразрядной камере и ее бомбардировка осуществляется ионами, образующимися в результате газового разряда.
Для распыления мишени используются ионы инертных газов (обычно аргон высокой чистоты). Источником ионов служит либо самостоятельный тлеющий разряд, либо плазма несамостоятельного разряда (дугового или высокочастотного). В настоящее время в производстве применяют различные процессы распыления, отличающиеся:
- характером питающего напряжения (постоянное, переменное, высокочастотное);
- способом возбуждения и поддержания разряда (автоэлектронная эмиссия, термоэмиссия, магнитное поле, электрическое высокочастотное поле);
- количеством электродов в газоразрядной камере (двухэлектродные, трехэлектродные и многоэлектродные системы).
Рассмотрим наиболее широко используемые ионно-плазменные методы получения тонких пленок.
Катодное распыление
Конструкция установки для катодного распыления, изображенной на рис. 4.4, состоит из газоразрядной камеры 1, в которую вводится рабочий газ (обычно аргон) под давлением 1 - 10 Па; катода 2, выполняющего функцию распыляемой мишени; анода 3 и закрепленной на ней подложки 4. Между анодом и катодом подается постоянное напряжение величиной несколько киловольт, обеспечивающее создание в межэлектродном пространстве электрического поля напряженностью порядка 0,5 кВ/см. Анод заземлен, а отрицательное напряжение к катоду подается через изолятор 5. Чтобы исключить загрязнение стеклянного колпака камеры, вблизи катода закрепляют экран 6.
 Электрическое поле, существующее между катодом и анодом, ускоряет электроны, образующиеся в межэлектродном пространстве в результате фотоэмиссии из катода, автоэлектронной (полевой) эмиссии, воздействия космического излучения или других причин. Если энергия электронов превышает энергию ионизации молекул рабочего газа, то в результате столкновения электронов с молекулами газа возникает газовый разряд, то есть образуется газоразрядная плазма. Для того чтобы электрон мог набрать необходимую для ионизации газа энергию, ему требуется обеспечить минимально необходимую длину свободного пробега. Только при этом условии электрон, двигаясь без столкновений, способен увеличить свою энергию до нужной величины. Однако, если длина свободного пробега электронов становится сравнимой с расстоянием между катодом и анодом, то основная часть электронов будет пролетать межэлектродное пространство без столкновений с молекулами рабочего газа. Газоразрядная плазма погаснет. Эти два фактора и определяют нижний и верхний пределы давлений газа в камере.
Электрическое поле, существующее между катодом и анодом, ускоряет электроны, образующиеся в межэлектродном пространстве в результате фотоэмиссии из катода, автоэлектронной (полевой) эмиссии, воздействия космического излучения или других причин. Если энергия электронов превышает энергию ионизации молекул рабочего газа, то в результате столкновения электронов с молекулами газа возникает газовый разряд, то есть образуется газоразрядная плазма. Для того чтобы электрон мог набрать необходимую для ионизации газа энергию, ему требуется обеспечить минимально необходимую длину свободного пробега. Только при этом условии электрон, двигаясь без столкновений, способен увеличить свою энергию до нужной величины. Однако, если длина свободного пробега электронов становится сравнимой с расстоянием между катодом и анодом, то основная часть электронов будет пролетать межэлектродное пространство без столкновений с молекулами рабочего газа. Газоразрядная плазма погаснет. Эти два фактора и определяют нижний и верхний пределы давлений газа в камере.
Образующаяся в результате газового разряда плазма состоит из электронов, ионов и нейтральных молекул рабочего газа. Ионы под воздействием электрического поля ускоряются и бомбардируют катод-мишень. Если энергия ионов превышает энергию связи атомов мишени, то происходит ее распыление. Кроме выбивания атомов с поверхности мишени, ионы способны выбить из нее вторичные электроны (вторичная электронная эмиссия). Эти вторичные электроны ускоряются и ионизируют молекулы рабочего газа; образующиеся при этом ионы бомбардируют мишень, вызывая вторичную электронную эмиссию, и процесс повторяется. Таким образом, газовый разряд поддерживает сам себя и поэтому называется самостоятельным тлеющим разрядом.
С повышением тока, протекающего через газоразрядную плазму, увеличивается плотность ионного потока и интенсивность распыления мишени. При некоторой плотности потока, зависящей от условий охлаждения мишени, начинает проявляться термоэлектронная эмиссия. Ток в разряде возрастает, а сам разряд становится несамостоятельным, приобретая характер дугового разряда. Для предотвращения перехода самостоятельного тлеющего разряда в дуговой высоковольтный источник питания должен иметь ограничения по мощности, а мишень интенсивно охлаждаться.
Для описания процессов катодного распыления мишени используют модели, основанные на двух механизмах. Согласно первому механизму распыленные атомы возникают в результате сильного локального разогрева поверхности мишени самим падающим ионом (модель «горячего пятна») или быстрой вторичной частицей (модель «теплового клина»). Второй механизм состоит в передаче импульса падающего иона атомам решетки материала мишени, которые, в свою очередь, могут передать импульс другим атомам решетки, вызвав тем самым каскад столкновений (модель столкновений).
Основной характеристикой эффективности процесса распыления является коэффициент распыления Кр, определяемый отношением количества выбитых атомов Nат к количеству бомбардирующих мишень ионов Nион:
 |
По существу коэффициент распыления представляет собой среднее число атомов мишени, выбитых одним ионом. Коэффициент распыления зависит от энергии ионов Еи, его массы (рода рабочего газа), материала мишени и в некоторой степени от ее температуры и состояния поверхности, угла бомбардировки, давления газа (при условии, что давление не выходит за пределы, при которых газоразрядная плазма гаснет).
Зависимость коэффициента распыления от энергии ионов, изображенная на рис. 4.5, носит немонотонный характер. Вначале при относительно небольших энергиях (менее 100 кэВ) с ростом энергии ионов Кр увеличивается, причем зависимость эта практически линейная. Затем рост Кр замедляется, кривая Кр = f(Eи) достигает насыщения, и для некоторых материалов наблюдается даже уменьшение коэффициента распыления.
 Качественно характер такой зависимости можно объяснить следующим образом. При небольших энергиях эффективность процесса распыления, характеризующаяся коэффициентом распыления, увеличивается с ростом энергии ионов, поскольку это приводит к увеличению импульса, передаваемого ионом атому мишени, а значит, и к увеличению вероятности выбивания его из своего узла. Если энергия иона превышает некоторое значение Eи max, то более вероятным становится процесс ионной имплантации. Это означает, что ускоренные до больших энергий ионы быстро проникают в приповерхностный слой мишени, теряя свою энергию за счет выбивания атомов мишени из своих узлов. Однако процесс выбивания атомов происходит уже на некоторой глубине от поверхности мишени, поэтому значительная часть выбитых атомов не может перейти из мишени в паровую фазу. В результате коэффициент распыления падает с ростом энергии ионов (или остается постоянным).
Качественно характер такой зависимости можно объяснить следующим образом. При небольших энергиях эффективность процесса распыления, характеризующаяся коэффициентом распыления, увеличивается с ростом энергии ионов, поскольку это приводит к увеличению импульса, передаваемого ионом атому мишени, а значит, и к увеличению вероятности выбивания его из своего узла. Если энергия иона превышает некоторое значение Eи max, то более вероятным становится процесс ионной имплантации. Это означает, что ускоренные до больших энергий ионы быстро проникают в приповерхностный слой мишени, теряя свою энергию за счет выбивания атомов мишени из своих узлов. Однако процесс выбивания атомов происходит уже на некоторой глубине от поверхности мишени, поэтому значительная часть выбитых атомов не может перейти из мишени в паровую фазу. В результате коэффициент распыления падает с ростом энергии ионов (или остается постоянным).
 |
Зависимость Кр = f(Eи), изображенная на рис. 4.5, достаточно хорошо описывается выражением
 |
где коэффициент К0 зависит от зарядов ядер бомбардирующего иона Z1 и атома мишени Z2 и периодически изменяется с изменением Z2; N2 – концентрация атомов мишени; Es – энергия сублимации материала мишени. Нормировочный коэффициент F определяется значением Eи max:
Величина а в формуле (4.8) представляет собой радиус экранирования заряда ядра электронами атомной оболочки:
 |
 |
Зависимость коэффициента распыления от массы ионов рабочего газа m1 и атомов мишени m2 описывается выражением
где k – коэффициент, характеризующий физическое состояние мишени и определяемый экспериментально; l - длина свободного пробега ионов в мишени, зависящая от концентрации атомов мишени.
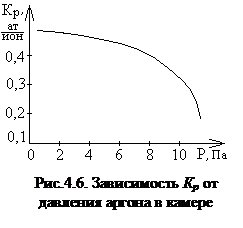 Увеличение давления рабочего газа в камере повышает вероятность столкновения распыленных атомов с молекулами рабочего газа, в результате чего часть атомов рассеивается в объеме или, отразившись от молекул рабочего газа, возвращается обратно на мишень. Поэтому увеличение давления приводит к уменьшению коэффициента распыления. Обратное рассеяние особенно существенно влияет на величину Кр, если масса распыленных атомов меньше массы молекул рабочего газа. На рис. 4.6 показана зависимость коэффициента распыления мишени из никеля от давления аргона в газоразрядной камере. Видно, что при небольших давлениях (на уровне 1 - 2 Па) коэффициент распыления изменяется слабо. Однако, начиная с давлений примерно равных 6 - 8 Па, коэффициент распыления с увеличением давления начинает резко падать.
Увеличение давления рабочего газа в камере повышает вероятность столкновения распыленных атомов с молекулами рабочего газа, в результате чего часть атомов рассеивается в объеме или, отразившись от молекул рабочего газа, возвращается обратно на мишень. Поэтому увеличение давления приводит к уменьшению коэффициента распыления. Обратное рассеяние особенно существенно влияет на величину Кр, если масса распыленных атомов меньше массы молекул рабочего газа. На рис. 4.6 показана зависимость коэффициента распыления мишени из никеля от давления аргона в газоразрядной камере. Видно, что при небольших давлениях (на уровне 1 - 2 Па) коэффициент распыления изменяется слабо. Однако, начиная с давлений примерно равных 6 - 8 Па, коэффициент распыления с увеличением давления начинает резко падать.
Зависимость коэффициента распыления от температуры, как правило, невелика и носит сложный характер. Она определяется процессами, изменяющими структуру мишени при ее нагреве. Если при нагреве мишени происходит термический отжиг дефектов, восстанавливающий структуру кристаллической решетки, то коэффициент распыления незначительно уменьшается. Коэффициент распыления может заметно измениться, если нагрев мишени сопровождается фазовыми превращениями (например, a-Fe с объемоцентрированной кубической решеткой при температурах выше 910 °С переходит в g-Fe, имеющее гранецентрированную кубическую решетку). Если структурных или фазовых изменений не происходит, то коэффициент распыления остается постоянным или может незначительно увеличиваться при повышении температуры.
Зависимость коэффициента распыления от угла падения носит немонотонный характер с максимумом в диапазоне углов от 30˚ до 60˚. На рис. 4.7 а в качестве примера приведена зависимость Kр(a) для мишени из алюминия, распыляемая ионами аргона с энергией 105 кэВ (коэффициент распыления выражен в относительных единицах). При нормальном падении Kр пропорционален энергии, рассеиваемой ионом в приповерхностном слое вещества, в пределах которого упругие столкновения с атомами приводят к распылению. При этом необходимо учитывать тот факт, что часть атомов мишени, выбитых из своих узлов на достаточно большом расстоянии от поверхности, покидать мишень не будет. С увеличением угла падения число смещенных атомов, достигающих поверхности и могущих покинуть кристалл, увеличивается, так как область смещений располагается под малым углом к поверхности (рис. 4.7б). Количество атомов мишени, выбитых из своих узлов, но остающихся в мишени, при этом уменьшается. Из геометрических расчетов следует, что число распыленных атомов возрастает в 1/cosa раз. Увеличение угла от 60˚ до 90˚ приводит к падению коэффициента распыления практически до нуля, поскольку в этом случае преобладающим становится отражение ионов от поверхности мишени.
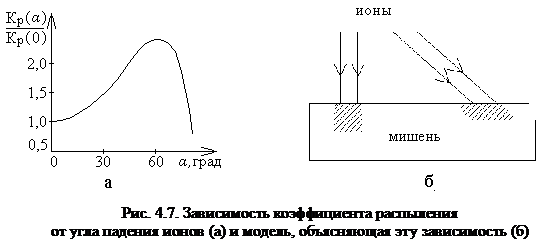 |
Важной особенностью катодного распыления является то, что в случае слабопроводящих подложек или при плохом контакте подложки с анодом на ее поверхности может образовываться распределенный отрицательный заряд электронов. Потенциал подложки относительно заземленного анода может достигать величины -100 В. Под влиянием электрического поля, созданного этим зарядом, возникает поток ионов остаточного газа, загрязняющий растущую на подложке пленку, а также поток ионов рабочего газа, способствующий десорбции атомов и молекул с подложки.
Дата добавления: 2018-05-12; просмотров: 779; Мы поможем в написании вашей работы! |

Мы поможем в написании ваших работ!
