Технология полупроводниковых структур
С комбинированной изоляцией
По этой технологии элементы ИМС со стороны подложки изолированы обратносмещенными p-n переходом, а между собой – диэлектриком.
Изопланарная структура

Формируем окна, в нитриде кремния (S3N4 осаждается из газовой фазы) для будущей изоляции по контуру коллекторных областей транзистора.

Глубокое окисление Si (чуть ниже скрытого слоя), Si3N4 при этом служит защитной маской

Травление Si3N4 и окисление всей поверхности

Далее процесс аналогичен ранее рассмотренным структурам (формирование p – базовых областей и т.д.).
Технологические недостатки:
1. Необходимость длительного и глубокого окисления. Здесь может произойти распределение примеси из  области в коллекторной области. Для уменьшения времени окисления и уменьшают толщину эпитаксиального слоя (≤ 4мкм).
области в коллекторной области. Для уменьшения времени окисления и уменьшают толщину эпитаксиального слоя (≤ 4мкм).
Преимуществом этой структуры является хорошая изоляция и, как следствие, более высокая степень интеграции, большее быстродействие.
Усовершенствованием изопланарной структуры является исключение операции сквозного глубокого окисления кремния и переход к структуре с изолирующими V-канавками. В этой структуре операция глубоко окисления заменяется сквозным протравлением эпитаксиального слоя с последующим окислением V – образных канавок в кремнии. Рельефная поверхность далее заполняется поликристаллическим Si.
|
|
|
Основные этапы:
Исходная пластина - монокристаллический Si с ориентацией  с эпитаксиальным слоем, покрытая окислом.
с эпитаксиальным слоем, покрытая окислом.
В окисле формируются окна, а затем окисляется сам Si
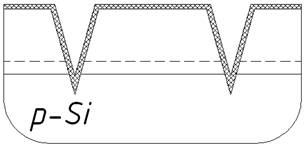
Наносится поликристаллический кремний, шлифуется, полируется и далее обычная диффузионная технология.
Ограничение: применение пластин с ориентацией  .
.
Анизотропное травление Si
Используется в технологии биполярных структур, в структурах с диэлектрической изоляции, в полипланарных структурах.
 V – образная форма связана с анизотропией травления монокристаллического Si. Скорость травления кремния зависит от кристаллографического направления. Примером анизотропного травителя является водный раствор этилендиаминпирокатехола ( ЭДЛ0).
V – образная форма связана с анизотропией травления монокристаллического Si. Скорость травления кремния зависит от кристаллографического направления. Примером анизотропного травителя является водный раствор этилендиаминпирокатехола ( ЭДЛ0).
Скорость травления при t=100○С: для  ; для ‹110› - 30мкм/ч, для ‹111› 3мкм/ч.
; для ‹110› - 30мкм/ч, для ‹111› 3мкм/ч.
Для пластины с ориентацией ‹100› при травлении образуются канавки точно V -образной формы с наклоном угла 54,7○ относительно поверхности.
ТЕМА 15
ТЕХНОЛОГИЯ МДП (МОП) СТРУКТУР
Полевой МОП – транзистор состоит из двух высоколегированных областей одного типа проводимости, которые называются И и С. Область, прилегающая к поверхности подложки между С и И, называется каналом. Канал покрыт тонким слоем диэлектрика (окисла кремния или другого изолирующего материала), на который наносится металлический электрод – затвор (З).
|
|
|


При работе в режиме обогащения между З и С прикладывается напряжение, создающее электрическое поле в области канала. В зависимости от направления поля к тонкой области канала притягиваются те или иные носители заряда. Если они имеют той же знак проводимости, что С и И, то возникает канальный ток. Т.к. слой диэлектрика под затвором очень тонкий, то величина поля в области канала может быть большой, т.е. небольшое напряжение на затворе может быть достаточно для протекания тока от И к С. В режиме обеднения при приложении противоположного поля С u И разъединяются. Принцип действия МОП – транзистора состоит в управлении потоком носителей между И и С.
МОП – транзистор является типовым схемным элементом МОП –ИМС. Он может выполнять роль как активного элемента, так и пассивного.
Технология МОП – транзистора содержит меньше операций, чем технология биполярного транзистора, т.к. отпадает необходимость изоляции транзисторов. Степень интеграции выше в МОП - ИМС до  транзисторов на одном кристалле. Наибольшее распространение получили ИМС с p – канальными транзисторами.
транзисторов на одном кристалле. Наибольшее распространение получили ИМС с p – канальными транзисторами.
|
|
|
Дата добавления: 2018-05-12; просмотров: 260; Мы поможем в написании вашей работы! |

Мы поможем в написании ваших работ!
