Технология полупроводниковых структур
ТЕМА 14
ТИПЫ СТРУКТУР ПОЛУПРОВОДНИКОВЫХ ИМС И ИХ ТЕХНОЛОГИЯ
Это биполярные и униполярные структуры
При сравнительной оценке различных типов структур учитываются следующие конструктивно-технологические показатели:
1. Качество межэлементной изоляции.
2. Площадь, занимаемая типичным функциональным элементом ИМС-транзистором.
3. Количество циклов избирательного легирования.
4. Количество циклов фотолитографии.
Среди планарных структур первой является диффузионно-планарная структура.

Концентрация примесей на границе р-п перехода мала
Эпитаксиально-планарная структура



Концентрация примесей равномерная
Схема технологического процесса формирования планарной диффузионной структуры
Коллекторные области формируются методом диффузии.
Исходная заготовка:
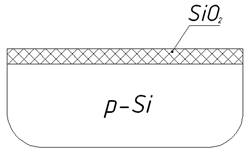
Первая ФЛ – формирование окон в окисле перед диффузией примеси в коллекторные области.

Диффузия примеси (например, фосфора) n-типа в коллекторную область и последующее окисление.

Диффузия проводятся в 2 этапа
Вторая ФЛ – вскрытие окон в окисле перед диффузией примеси в базовые области

Диффузия примеси p-типа (например, бора) в базовые области.

Третья ФЛ и вскрытие окон в области эмиттеров и приконтактные области коллекторов

Диффузия n+ – примеси в эмиттерные области и приконтактные коллекторные области, и последующее окисление.
|
|
|

Четвертая фотолитография (ФЛ) и вскрытие окон под контакты к диффузионным областям.

Металлизация поверхности

Пятая фотолитография. Избирательное травление Al и образование контактных площадок и межсоединений.

Таким образом, мы сформировали транзисторную структуру. Остальные элементы изготовляются одновременно с транзистором. Например:

Емкость может быть образованная Б-К переходом.
n-p-n транзисторы используются чаще, т.к. их обратные токи в меньшей степени зависят от свойств окисла, по сравнению с p-n-p транзистором.
Основной недостаток диффузионных планарных структур – сравнительно большое сопротивление коллектора. Дно коллекторной области под базой имеет малый поперечный размер. Это приводит к увеличению напряжения  и времени переключения транзистора. Для устранения этого недостатка используют структуры со скрытым
и времени переключения транзистора. Для устранения этого недостатка используют структуры со скрытым  слоем.
слоем.
Схема процесса получения планарно-эпитаксиальной структуры
Планарно-эпитаксиальные ИМС – это ИМС, в которых коллекторные области сформированы методом эпитаксии.
В качестве исходной заготовки используется полупроводниковая пластина p-типа.
|
|
|

Для нанесения эпитаксиального слоя одну из сторон пластины освобождают от окисла.
Наращивание монокристаллического Si n- типа.

Окисление поверхности и первая фотолитография для вскрытия окон в виде узких, замкнутых дорожек, соответствующих изолирующим областям.


Через окна проводится диффузия p – примеси до смыкания с подложкой и последующее окисление.

В результате получили области n-типа, изолированные друг от друга. Далее по аналогии с диффузионной планарной структурой формируются базовые области, затем эмиттерные и приконтактные коллекторные области, затем контактные площадки, межсоединения и защитный слой.
Последовательность операций при получении эпитаксиальной планарной структуры со скрытым слоем
Такая структура дает компромисс между необходимостью высокой концентрации n – примесей для коллекторного тока и опасностью при этом перед снижением пробивного напряжения на переходе «база – коллектор».

С помощью фотолитографии делаются окна для диффузии n – примеси, например, мышьяка (As). Аs имеет малый коэффициент диффузии, что важно для скрытого слоя при последующих нагревах.
|
|
|

Диффузия n – примеси и стравливание окисла

Поверхность пластины готовится для эпитаксии
Эпитаксия Si (формируется n – Si).

Окисление и далее технологический процесс формирования транзисторных структур идет аналогично выше рассмотренным структурам. (разделительная диффузия, формирование p – базовых областей, эмиттерных и приконтактных коллекторных  областей, формирование контактов и защитных поверхностей).
областей, формирование контактов и защитных поверхностей).
Общим недостатком таких структур является то, что здесь имеются токи утечки и паразитные емкости (  ).
).
Технология полупроводниковых структур
С диэлектрической изоляцией
В таких структурах каждый элемент расположен как бы в своеобразном кармане, а именно в области монокристаллического кремния, ограниченной слоем двуокиси Si (SiO2). Такая технология позволяет во-первых существенно повысить пробивное напряжение и значительно сократить расстояние между элементами (до 8-10мкм). Во-вторых- уменьшить токи утечки. В-третьих- уменьшить  . Все это позволяет увеличить частоту аналоговых микросхем и увеличить быстродействие цифровых микросхем.
. Все это позволяет увеличить частоту аналоговых микросхем и увеличить быстродействие цифровых микросхем.

Здесь возможно изготовление структур со скрытым слоем и без него. Если содержится  эпитаксиальный слой, то получается структура со скрытым слоем.
эпитаксиальный слой, то получается структура со скрытым слоем.
|
|
|

В исходной пластине с помощью ФЛ вытравливаются участки SiO2, а потом травится и сам Si по контуру будущих элементов. В результате на пластине образуются канавки по замкнутому контуру.

Полученную рельефную поверхность окисляют

Затем методом осаждения всю поверхность покрывают поликристаллическим Si.

Обратную сторону шлифуют до удаления монокристаллического Si вплоть до вскрытия окисла.

Таким образом, мы сформировали области транзистора со скрытым  слоем. После полирования производят травление для удаления структурно нарушенного слоя. После травления поверхность пластины окисляют. Далее реализуют диффузионную технологию базовых p – областей,
слоем. После полирования производят травление для удаления структурно нарушенного слоя. После травления поверхность пластины окисляют. Далее реализуют диффузионную технологию базовых p – областей,  эмиттерных и приконтактных коллекторных областей и далее контактных межсоединений.
эмиттерных и приконтактных коллекторных областей и далее контактных межсоединений.
Основные трудности:
1. Проведение прецизионного шлифования с исключительно млыми отклонениями толщины сошлифованного слоя.
2. Нарушение монолитности подложки (толстый слой напыленного поликристалического кремния). Это вызывает внутренние напряжения, приводящие к короблению подложки.
3. Затруднен теплоотвод от транзисторной структуры
Дата добавления: 2018-05-12; просмотров: 480; Мы поможем в написании вашей работы! |

Мы поможем в написании ваших работ!
