Логічні елементи на польових транзисторах
структури „метал-напівпровідник” з бар’єром Шотткі
Параметри інтегральних мікросхем на біполярних і уніполярних (польових) транзисторах в значній мірі залежать від параметрів напівпровідникового матеріалу, який був використаний для їх створення. Наприклад, частотні параметри кремнієвих транзисторів суттєво обмежені рухливістю носіїв заряду у кремнії, тому збільшити швидкодію цифрових інтегральних мікросхем можна шляхом використання для їх створення не кремнію, а іншого матеріалу з більш високою рухливістю носіїв електричного заряду. До таких матеріалів, наприклад, відносяться арсенід галію (GaAs), фосфід індію (InP), арсенід індію (InAs), антимонід індію (InSb) та інші. З перерахованих вище матеріалів за комплексом технологічних та електричних властивостей найбільш придатним для виготовлення інтегральних мікросхем є арсенід галію, деякі фізичні параметри якого наведені в табл. 4.9. Для порівняння у табл. 4.9 наведені такі ж параметри для кремнію.
Як можна бачити з табл. 4.9 арсенід галію має у 6 разів більшу рухливість електронів і у 1,3 рази більшу ширину забороненої зони ніж кремній. Перший із зазначених вище параметрів гарантує електронним компонентам на основі GaAs кращі частотні характеристики, а другий - більш високу робочу температуру. Перевагою арсеніду галію є також більш високий власний питомий електричний опір, що дає можливість спростити ізоляцію компонентів на кристалі інтегральної мікросхеми.
|
|
|
Таблиця 4.9
Параметри арсеніду галію GaАs і кремнію Si
при температурі 300 К
| Параметр | Одиниця виміру | GaAs | Si |
| Температура плавлення | оС | 1238 | 1412 |
| Діелектрична проникність | - | 11 | 12 |
| Питомий електричний опір (власний) | Ом×м | 105¸107 | (2,3¸2,4)×103 |
| Ширина забороненої зони | еВ | 1,43 | 1,12 |
| Концентрація носіїв заряду у власному напівпровіднику | м-3 | 2∙1012 | 1,5∙1016 |
| Рухливість носіїв заряду: електронів дірок | м2×В-1×с-1 | 0,85 0,042 | 0,135 0,048 |
| Час життя неосновних носіїв заряду | с | 10-8 | 10-3 |
| Щільність поверхневих станів у МДН структурі | м-2 | 1016¸1017 | 1014 |
Слід однак зазначити, що низька, порівняно з електронами, рухливість дірок в арсеніді галію, а також мала тривалість життя неосновних носіїв заряду роблять неможливим створення на основі GaAs біполярних транзисторів за традиційним варіантом їх структури, який використовується у технології ІМС на основі кремнію. Створення же польових транзисторів зі структурою „метал-діелектрик-напівпровідник” на основі GaAs ускладнює висока щільність поверхневих станів на границі напівпровідник-діелектрик, а також ті складнощі, що виникають при створенні діелектричних шарів на поверхні напівпровідникового кристалу арсеніду галію. Тому для створення транзисторів на основі GaAs потрібна спеціальна технологія, яка б враховувала хімічні та електрофізичні особливості цієї напівпровідникової сполуки. Технічним розв’язанням, яке дало можливість подолати означені вище проблеми є польові транзистори з керуючим затвором у вигляді структури „метал-напівпровідник” з потенціальним бар’єром Шотткі (МЕН-транзистори або ПТШ), а також польові транзистори з керуючим р-n- затвором. МЕН-транзистори мають ряд переваг над польовими транзисторами з p-n- затвором, тому розглянемо їх докладніше.
|
|
|
Бар’єр Шотткі, сформований в межах границі між металом і напівпровідниковим арсенідом галію, як і p-n перехід, має однобічну провідність. Ця властивість дає можливість створити на основі арсеніду галію польовий транзистор з бар’єром Шотткі (ПТШ). Структура такого транзистора у поперечному перетині наведена на рис. 4.24. Він складається з напівпровідникової пластини 1, у якій сформовані області витоку 3 та стоку 9. В каналі транзистора 7 розташована область 5 збіднена носіями заряду (область бар’єру Шотткі). Металеві контакти до витоку, затвору і стоку транзистора позначені цифрами 4, 6, 8 відповідно. Ізоляцію електродів транзистора один від одного забезпечує діелектричний шар 2 на поверхні пластини GaAs.
|
|
|
Як напівпровідникову пластину (підкладку) транзистора застосовують арсенід галію з великим питомим електричним опором (~ 106 Ом∙м), який обумовлений власною провідністю GaAs (це так званий напівізолюючий арсенід галію). У поверхневій області пластини методом іонного легування донорними домішками (S, Se, Te, Si) створюють n+ області витоку -3 і стоку - 9 з високою концентрацією донорів, а також тонкий шар каналу з n-типом провідності - 7 (рис. 4.24). Концентрація донорів у каналі складає Nдк = (1¸3)∙1023 м-3, а товщина шару каналу h = 0,1¸0,3мкм.

|
| Рис. 4.24. Поперечний перетин польового транзистора з бар’єром Шотткі реалізованого на основі структури „метал-напівпровідник” |
Металеві електроди до витоку і стоку транзистора, виконані як шари AuGe/Pt (105/28 нм), що утворюють омічні контакти до n+ областей пластини GaAs. Металевий електрод затвора на основі шарів Ti/Pt/Au (100/50/150 нм), утворює з арсенідом галію випрямляючий контакт з потенціальним бар’єром Шотткі. Цей бар’єр створює в шарі n-GaAs область об’ємного заряду іонізованих донорів 5, яка збіднена вільними електронами. Довжина затвору, яку визначають розміри металевого електрода 6 (рис. 4.24), складає 0,5¸1 мкм, а відстань між витоком і стоком 1,5¸3 мкм.
|
|
|

|
| Рис. 4.25. Енергетична діаграма контакту метал-напівпровідник |
Для розуміння принципу дії МЕН-транзисто-ра розглянемо енергетичну діаграму контакту метал-напівпровідник, наведену на рис. 4.25. Ця діаграма показує як енергія електрона Е залежить від координати x. Відповідно до структури МЕН-транзистора (рис. 4.24) приймемо, що вісь x спрямована у глибину пластини GaAs по нормалі до її поверхні, а початок відліку координати x співпадає з контактною поверхнею металевого електрода 6 і арсеніду галію. На рис. 4.25 використані такі позначення: Еv, Ес – енергії, що відповідають стелі валентної зони і дну зони провідності відповідно; ЕFM, ЕFН – енергії Фермі в металі та напівпровіднику; Е0 - енергія, електрона в вакуумі в стані спокою; ФМ, ФН – роботи виходу електронів з металу та напівпровідника.
Енергетична діаграма (рис. 4.25) відповідає випадку, коли робота виходу електронів з напівпровідника ФН менша за роботу виходу з металу ФМ. Тоді в момент створення контакту метал-напівпровідник потік електронів з напівпровідника, обумовлений термоелектронною емісією, перевищує зворотний потік електронів з металу. Як наслідок метал заряджається негативно, а напівпровідник позитивно. Виникає електричне поле, яке перешкоджає переходу електронів з напівпровідника до металу, тому потік електронів з напівпровідника зменшується і через деякий час наступає рівновага, коли він стає таким же, як зворотний потік електронів з металу. Це відбувається, коли рівні Фермі в металі і напівпровіднику зрівняються, тобто ЕFM = FFН. Саме такому випадку відповідає діаграма на рис. 4.25. У стані рівноваги до контакту прикладена контактна різниця потенціалів φк, добуток якої на заряд електрона e дорівнює різниці робіт виходу електрона:
еφк = ФМ - ФН. (4.26)
Після встановлення рівноваги, величини об’ємного заряду у металі і напівпровіднику однакові. Але оскільки концентрація вільних електронів n у металі набагато перевищує концентрацію електронів у напівпровіднику, то товщини області просторового заряду (ОПЗ) у металі dМ і напівпровіднику dН значно відрізняються. Величина dН для напівпровідника, знайдена з рішення рівняння Пуассона, визначається співвідношенням:
dН =  , (4.27)
, (4.27)
де е - заряд електрона, ε0 - електрична стала, ε - відносна діелектрична проникність.
Відповідно з (4.27) при ФМ – ФН = 1еВ і концентрації електронів у зоні каналу МЕН-транзистора n=1023 м-3, значення dН = 1,15∙10-7м. Товщина ОПЗ у металі при цьому не перевищує dМ=10-10 м.
Важливо відзначити, що ОПЗ у металі і напівпровіднику відрізняються за своєю фізичною природою. У металі ОПЗ – це приконтактна область, яка, порівняно з об’ємом металу, збагачена електронами розташованими на рівні Фермі. У напівпровіднику - це приконтактна область, збіднена електронами, яка носить назву „шар Шотткі”. Вона містить позитивно заряджені нерухомі іони донорних домішок розташовані у кристалічній гратці арсеніду галію.
Товщину шару Шотткі dН можна змінювати шляхом прикладення між затвором і витоком (підкладкою) структури „метал-напівпровідник” (рис. 4.24) напруги U. Ця зміна відбувається за рахунок збільшення або зменшення, в залежності від полярності прикладеної напруги, висоти потенціального бар’єру ejк на межі контакту метал-напівпровідник. В цьому випадку формула (4.27) для товщини ОПЗ має вигляд:
dН =  . (4.28)
. (4.28)
Саме ця функціональна залежність товщини ОПЗ від напруги лежить в основі принципу дії польових транзисторів з бар’єром Шотткі.
Для забезпечення функціонування МЕН–транзисторів між його затвором і витоком прикладають керуючу напругу Uзв, а між стоком і витоком – постійну позитивну напругу від джерела живлення Uсс. В залежності від властивостей контакту метал-напівпровідник і значення відношення геометричних розмірів каналу і товщини шару Шотткі h/dН при напрузі Uзв = 0 В можливі два варіанти функціонування МЕН-транзистора. Перший з них відповідає відношенню h/dН £ 1. У цьому випадку область каналу на всю глибину перекрита областю просторового заряду збідненою носіями заряду, в наслідок чого стік і витік відокремлені один від одного великим опором. Тому транзистор при Uсв = 0 В закритий і його називають початково закритим.
У випадку, коли h/dН > 1, область каналу лише частково перекрита областю просторового заряду і тому при Uсв ≠ 0 В через неї протікає струм. Як наслідок транзистор при Uсв = 0 В відкритий і його називають початково відкритим. За станом каналу початково закриті ПТШ подібні до МОН-транзисторів з індукованим каналом, а початково відкриті - до МОН-транзисторів з вбудованим каналом.
Стоко-затворні характеристики початково закритого і початково відкритого транзисторів з керуючим бар’єром Шотткі наведені на рис. 4.26. Для обох типів транзисторів існує деяка напруга Uзв, при якій струм стоку стає рівним нулю. Цю напругу, як і для МОН-транзисторів, називають пороговою напругою (Uпор). Її можна знайти з умови, що область каналу на всю товщину h перекрита областю просторового заряду dН(Uпор) = h. Звідси, на підставі (4.28) можна одержати вираз для порогової напруги Uпор:
 . (4.29)
. (4.29)
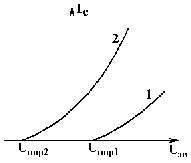
|
| Рис. 4.26. Стоко-затворні характеристики початково закритого (1) і відкритого (2) польових транзисторів з керуючим бар’єром Шотткі |
Звичайно вважають, що концентрація електронів в області каналу дорівнює концентрації донорів: n = Nд. Як випливає із співвідношення (4.29) порогову напругу ПТШ Uпор можна змінювати шляхом зміни товщини області каналу h. Для сучасних початково відкритих ПТШ така напруга складає -2,5 ¸ -0,5 В, а для початково закритих 0 ¸ 0,2 В. Максимально можливе значення напруги Uзв для транзисторів обох типів обмежено напругою, при якій виникає суттєвий струм затвору, що є небажаним для польових транзисторів.
З описаного вище можна зробити висновок, що МЕН-транзистори багато у чому подібні до МОН-транзисторів. Типові параметри МЕН-транзисторів, що наведені у табл. 4.10, свідчать про їхню придатність для побудови інтегральних мікросхем логічних елементів.
Базовими ключами схемотехніки таких елементів є ключі на польових транзисторах з бар’єром Шотткі. Серед відомих схем ПТШ-ключів найбільш поширеною є схема ключа з динамічним навантаженням, показана на рис. 4.27. Вона складається з двох послідовно увімкнених транзисторів: початково закритого транзистора VТ1 і початково відкритого транзистора VТ2. Транзистор VТ1 виконує функцію активного компонента схеми, який змінює свій стан під дією вхідної напруги Uвх. Транзистор VТ2 виконує функцію динамічного стокового навантаження транзистора VТ1. Оскільки затвор VТ2 з’єднаний з витоком, то завжди Uзв = 0 В і, згідно стоко-затворній характеристиці (рис. 4.26, крива 2), транзистор VT2 відкритий незалежно від напруги Uвх, яка діє на вході ключа.
Таблиця 4.10
Параметри польових транзисторів з бар’єром Шотткі
| Параметр | Одиниця виміру | Значення |
| Усереднені розміри транзистора | мкм | 10 ¸ 15 |
| Відстань між витоком і стоком | мкм | 2 ¸ 5 |
| Довжина затвору | мкм | 0,5 ¸ 1,0 |
| Ширина затвору | мкм | 5 ¸ 20 |
| Товщина області каналу | нм | 5 ¸ 150 |
| Концентрація донорів в області каналу | м-3 | (1 ¸ 5)∙1023 |
| Рухливість електронів у зоні каналу | м2×В-1×с-1 | 0,4 ¸ 0,5 |
| Висота потенціального бар’єра Шотткі | В | 0,7 ¸ 0,8 |
| Порогова напруга: початково закритого ПТШ початково відкритого ПТШ | В | 0 ¸ 0,2 -2,5 ¸ -0,5 |
| Крутизна стоко-затворної характери-стики на одиницю ширини області каналу | См/м | 100 ¸ 200 |
| Питома ємність на одиницю ширини області каналу: затвор-виток затвор-сток сток-виток | пФ/м | 500 ¸ 1500 100 ¸ 200 50 ¸ 100 |
| Порогова частота | ГГц | 15 ¸ 30 |
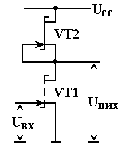
|
| Рис. 4.27. Схема ключа з динамічним навантаженням на польових транзисторах Шотткі |
Принцип дії цього ключа подібний до принципу дії МОН-ключа з динамічним навантаженням (див. підрозділ 2.3.2). При наявності на вході схеми (рис. 4.27) напруги низького рівня U0 (UIL), яка має значення менше за порогову напругу UпорVT1, транзистор VТ1 знаходиться у закритому стані, тобто має опір набагато більший, ніж опір відкритого транзистора VТ2. Тому практично вся напруга живлення падає на стоці VT1 і на виході ключа створюється високий рівень напруги Uвих = U1 (UOH) » Uсс. При Uвх = U1 (UIH) > UпорVT1 транзистор VТ1 відкривається, і його опір, завдяки конструктивним особливостям, стає меншим, ніж опір транзистора VТ2, тому на VТ1 падає незначна частка напруги живлення Uсс, яка відповідає низькому рівню U0 (UOL). Таким чином, ключ на польових транзисторах Шотткі, як і інші ключі, які були розглянуті у розділі 2 є логічним елементом НЕ.
Логічні елементи АБО-НЕ створюють на ПТШ шляхом приєднання паралельно транзистору VТ1 в схемі на рис. 4.27 подібних початково закритих транзисторів. Кількість транзисторів, що приєднуються, визначає коефіцієнт об’єднання Kоб, який треба забезпечити для логічного елемента АБО-НЕ. Затвори початково закритих ПТШ є входами такого ЛЕ, а принцип його дії подібний до принципу дії логічного елемента АБО-НЕ на МОН-транзисторах з динамічним навантаженням (див. підрозділ 4.4.1).
Побудова схем логічних елементів І-НЕ на ПТШ може бути здійснена таким же чином, як і для елементів І-НЕ МОНТЛ (підрозділ 4.4.1), тобто шляхом послідовного з’єднання активних транзисторів, включених на загальний навантажувальний транзистор. Слід, однак, зазначити, що таке з’єднання завдяки особливостям ПТШ (малі значення Uпор і U1 (UOH), збільшення U0 (UOL) при послідовному з’єднанні транзисторів) не забезпечує задовільної для цифрових мікросхем завадостійкості, тому логічні елементи І, І-НЕ на МЕН-транзисторах будують з використанням схемотехнічних рішень, які були знайдені раніше в емітерно-зв’язаній логіці (ЕЗЛ) на біполярних транзисторах.
Схема на МЕН-транзисторах, що реалізує на своїх виходах логічні функції 2І та 2І-НЕ представлена на рис 4.28.
Характерною особливістю такої схеми є наявність пар початково закритих МЕН-транзисторів VТ5-VТ6 і VТ7-VТ8, витоки яких об’єднані між собою. Включені таким чином транзистори сумісно з резисторами R1, R2, R3 утворюють перемикач струму, який тече через ланцюг об’єднаних витоків пари транзисторів. Цей струм може перемикатися між ланцюгами транзисторів, що утворюють пару. Станом цих транзисторів керують взаємно інверсні сигнали. Для їх одержання в схемі використовуються два інвертори, реалізовані як ключі з динамічним навантаженням на МЕН–транзисторах VT1, VT3 і VT2, VT4. Входи інверторів, як і затвори VT5, VT7 пар, підключені до входів логічного елемента x1, x2. На затвори інших транзисторів пар VT6, VT8 надходять сигнали  ,
,  з виходів інверторів. Вихідні сигнали логічного елемента Y1 і Y2 знімають зі стоків транзисторів пари VТ5, VТ6. Стоковим навантаженням цих транзисторів є резистори R1 і R2, а резистор R3 виконує функцію навантаження зв’язаних витоків транзисторів VТ7 і VТ8 другої пари. Саме струм, що протікає через резистор R3 перемикається між транзисторами, які утворюють пару. Зазначимо, що всі початково закриті ПТШ схеми мають однакові параметри, зокрема, однакову порогову напругу Uпор.
з виходів інверторів. Вихідні сигнали логічного елемента Y1 і Y2 знімають зі стоків транзисторів пари VТ5, VТ6. Стоковим навантаженням цих транзисторів є резистори R1 і R2, а резистор R3 виконує функцію навантаження зв’язаних витоків транзисторів VТ7 і VТ8 другої пари. Саме струм, що протікає через резистор R3 перемикається між транзисторами, які утворюють пару. Зазначимо, що всі початково закриті ПТШ схеми мають однакові параметри, зокрема, однакову порогову напругу Uпор.

|
| Рис. 4.28. Схема логічного елемента І та І-НЕ на МЕН – транзисторах і його умовне зображення |
Як ТТЛШ і КМОПТЛ логічні елементи на МЕН-транзисторах для кодування нуля і одиниці використовують позитивну логіку, тобто високий рівень напруги U1 відповідає „1”, а низькій U0 – „0”. З урахуванням цього побудуємо таблицю справжності (табл. 4.11) для схеми, наведеної на рис. 4.28.
| Таблиця 4.11 Таблиця справжності базового логічного елемента на польових транзисторах Шотткі | ||||||||||||||||||||
|
При подачі на обидва входи ЛЕ напруги високого рівня U1, яка перевищує значення Uпор, транзистори VТ5 і VТ7 відкриваються, а VТ6 і VТ8 закриваються інверсними сигналами U0 < Uпор, що надходять на їх затвори з виходів інверторів на транзисторах VТ1, VТ3 і VТ2, VТ4. Як наслідок струм через резистор R3 протікає через ланцюг: резистор R1, відкриті транзистори VТ5 і VТ7. На стоці закритого VТ6, а відповідно, на виході схеми Y2 встановлюється високий рівень напруги U1 логічної „1” близький до напруги живлення Uсс, а на стоці відкритого VТ5 (на виході Y1) низький рівень напруги U0 логічного „0”.
При наявності хоча б на одному зі входів x1, x2 (або на обох цих входах) низького рівня напруги U0 закривається один з транзисторів VТ5, VТ7 (або обидва ці транзистори) і відкривається один з транзисторів VТ6, VТ8 (або обидва ці транзистори). Струм резистора R3 в цьому випадку перемикається на праву гілку транзисторних пар, тобто або крізь транзистор VТ6 або крізь транзистор VТ8 (або одночасно крізь обидва ці транзистори, коли вони знаходяться у відкритому стані). Наприклад, коли x1 = U1, x2 = U0, то закритими є транзистори VТ6, VТ7, а відкритими VТ5, VТ8, тому струм резистора R3 перемикається на ланцюг: резистор R2, транзистор VТ8. На стоці транзистора VТ8, а, відповідно, на виході Y2 встановлюється низький рівень напруги U0 логічного „0”. Оскільки VТ7 закритий, а VТ5 відкритий на виході Y1 створюється високий рівень напруги U1 = Uсс логічної „1”. Як можна переконатися, подібний стан виходів Y1, Y2 має місце і для інших комбінацій сигналів на входах x1, x2, якщо хоча б на одному з них діє низькій рівень U0 логічного „0”.
Таким чином, згідно побудованій таблиці справжності (табл. 4.11), схема логічного елемента, показана на рис. 4.28, відносно вхідних змінних x1, x2 на виході Y1 реалізує функцію Шеффера  (2І-НЕ), а на виході Y2 - кон’юнкцію (2І).
(2І-НЕ), а на виході Y2 - кон’юнкцію (2І).
Описаний логічний елемент є базовим елементом арсенід галієвих мікросхем серії 6500 до складу якої входять лічильники, регістри, тригери, компаратори, оперативні запам’ятовуючі пристрої (ОЗП) і логічні елементи. Зокрема до цієї серії входять мікросхеми логічних елементів: 6500ЛИ1 (10G011B) - два логічних елементи 2І; К6500ЛР1 (HMD11104-2) - логічний елемент 2І-АБО. В дужках вказані закордонні функціональні аналоги мікросхем. Параметри інтегральних мікросхем логічних елементів серії 6500 наведені у табл. 4.12.
Значення цих параметрів свідчать про те, що цифрові інтегральні мікросхеми на арсенід галієвих ПТШ можуть за деякими показниками скласти конкуренцію кремнієвим ІМС на біполярних транзисторах Шотткі (табл. 4.3) і КМОН-транзисторах (табл. 4.8). Однак, вони поступаються кремнієвим мікросхемам споживаною потужністю, завадостійкістю, ступенем інтеграції, більшим розкидом параметрів і їх залежністю від відстані між сусідніми компонентами на кристалі мікросхеми.
Таблиця 4.10
Параметри ІМС логічних елементів серії 6500 на
МЕН–транзисторах
| Параметр | Значення |
| Напруги двохполярного джерела живлення, В | + 4; - 2,4 |
| Вихідна напруга низького рівня U0вих (UOL), В | -0,2 ¸ 0,1 |
| Вихідна напруга високого рівня U1вих (UOH), В | 0,9 ¸ 1,5 |
| Вхідний струм низького рівня I0вх (IIL), мА, | -0,5 |
| Вхідний струм високого рівня I1вх (IIН), мА, | 1 |
| Завадостійкість, В: відносно рівня логічного „0” U0пер (ML) відносно рівня логічної „1” U1пер (MH) | 0,1 0,1 |
| Середній час затримки поширення сигналу 0,5(tзп1,0+tзп0,1), 0,5(tPHL+ tPLH), пс | 150 |
| Робота перемикання, пДж | 0,15 |
| Робоча частота, ГГц | 1 |
Контрольні запитання
1. На яких базисах і типах логіки побудовані цифрові схеми сучасних комп’ютерів ?
2. Які параметри мають логічні елементи і як визначити їх статичну завадостійкість?
3. Яку структуру має інтегральний багатоемітерний транзистор (БЕТ) ? Поясніть природу паразитного транзисторного ефекту БЕТ і шляхи його подолання.
4. Нарисуйте схему базового логічного елемента ТТЛШ. Виходячи з рівнів U0 та U1 прийнятих у ТТЛШ для кодування логічних „0” та „1” і фізичних принципів роботи схеми побудуйте таблицю справжності базового елемента ТТЛШ.
5. Визначте завадостійкість базового елемента ТТЛШ відносно рівнів логічного „0” і „1”.
6. Поясніть причину, яка викликає стрибок струму в шині живлення при перемиканні елементів ТТЛШ. Які засоби використовують для боротьби з негативним впливом стрибка струму на роботу інтегральних мікросхем ТТЛШ ?
7. Які переваги і недоліки використання в схемах логічних елементів ТТЛШ вхідного каскаду на діодах Шотткі замість багатоемітерного транзистора Шотткі ?
8. Яким чином узгоджуються транзистори VT3, VT5 (рис. 4.4) і VT5, VT7 (рис. 4.7), що утворюють складовий транзистор в схемах базових логічних елементів ТТЛШ ?
9. Поясніть призначення ланцюгів R4, VT4 і R5, VT6 в схемах на рис. 4.4 і рис. 4.7.
10. Поясніть, чому використання зовнішніх резисторів у схемах на логічних елементах ТТЛШ може впливати на логіку роботи таких схем.
11. Який логічний стан (логічний „0” або „1”) буде на виході елемента, схема якого наведена на рис. 4.4, якщо між одним з його входів і загальною шиною (землею) увімкнути резистор з опором R = 5,2 кОм, а інший вхід залишити вільним ? При аналізі прийняти Uсс = 5 В, R1 = 4 кОм, U1min = 2,4 В U0max = 0,4 В.
12. Чому не можна об’єднувати виходи стандартних логічних елементів ТТЛШ ?
13. Виходи двох елементів ТТЛШ 2АБО-НЕ з відкритим колектором об’єднали і підключили через резистор до шини живлення. Яка логічна функція буде реалізована на об’єднаному виході ?
14. Нарисуйте схему базового елемента ТТЛШ з трьома вихідними станами і поясніть принцип її роботи. Де використовують Z-стан логічних елементів ?
15. Для схеми базового елемента КМОНТЛ (рис. 4.18а) побудуйте таблицю справжності виходячи з рівнів U0 та U1 КМОНТЛ і фізичних принципів роботи схеми.
16. Чому елементи КМОНТЛ практично не споживають потужність у статичному режимі і які чинники зростання їх споживаної потужності у динамічному режимі ?
17. Які переваги і недоліки КМОНТЛ порівняно з ТТЛШ ?
18. Поясніть принцип дії кола (рис. 4.19) для захисту входів мікросхем КМОНТЛ.
19. Поясніть природу тиристорного ефекту в інтегральних структурах КМОНТЛ.
20. З якою метою в логічному елементі КМОНТЛ з відкритим стоком на рис. 4.21 використовується КМОН-ключ на транзисторах VT5, VT6 ?
21. Нарисуйте схему логічного елемента НЕ КМОНТЛ з трьома вихідними станами і поясніть принцип його дії.
22. До входів кон’юнктора 2І на діодах підключені елементи 2АБО-НЕ КМОНТЛ. Яка логічна функція реалізується на виході кон’юнктора відносно вхідних змінних 2АБО-НЕ ? Яка напруга логічного нуля U0 на виході кон’юнктора, якщо на виході елементів 2АБО-НЕ U0 = 0 В, а пряме падіння напруги на діоді Uд.пр. = 0,8 В ?
23. Поясніть принцип дії польового транзистора з бар’єром Шотткі (ПТШ).
24. Нарисуйте стоко-затворні характеристики початково закритого и початково відкритого ПТШ.
25. Нарисуйте схему і поясніть принцип дії ключа на ПТШ.
26. Поясніть принцип дії логічного елемента на ПТШ, показаного на рис. 4.28.
Розділ 5.ТРИГЕРНІ ЕЛЕМЕНТИ ПАМ’ЯТІ ЦИФРОВИХ ПРИСТРОЇВ
Дата добавления: 2018-04-05; просмотров: 551; Мы поможем в написании вашей работы! |

Мы поможем в написании ваших работ!
