Факторы, влияющие на скорость диффузии
На скорость диффузии оказывают влияние такие факторы, как температура; тип примесных атомов и среда, в которой они диффундируют; наличие дефектов кристаллической решетки; концентрация вводимой примеси и концентрация примеси, уже имеющейся в пластине. С повышением температуры скорость диффузии возрастает, поскольку увеличивается вероятность перескока примесного атома из одного положения в другое, причем зависимость эта примерно экспоненциальная.
Тип атомов также влияет на скорость диффузии, поскольку для разных атомов различны энергия активации диффузии и, что более важно, может быть различен и сам механизм диффузии. Как уже отмечалось, примесные атомы, диффундирующие по вакансионному механизму, имеют значительно более низкий коэффициент диффузии, чем атомы, диффундирующие по междоузлиям.
Влияние дефектов кристаллической структуры на скорость диффузии примесных атомов обусловлено тем, что дефекты создают вокруг себя механические напряжения, способствующие образованию вакансий. Это, в свою очередь, увеличивает скорость диффузии атомов, перемещающихся по вакансионному механизму.
Влияние концентрации примесных атомов (вводимых в пластину или уже имеющихся в ней) обусловлено тем, что при высоких температурах практически все они находятся в ионизированном состоянии: доноры становятся положительно заряженными ионами, акцепторы – отрицательно заряженными. Если, например, пластина была легирована донорами, а в нее вводятся акцепторы, то за счет дополнительного воздействия электрического поля доноров ионы-акцепторы будут диффундировать быстрее. Если же пластина была легирована донорами, а в нее вводятся снова доноры, то их скорость диффузии из-за электрического поля будет меньше.
|
|
|
На скорость диффузии влияет и концентрация самой вводимой в пластину примеси, причем это влияние проявляется заметно лишь при условии, что концентрация вводимой примеси превышает собственную концентрацию свободных носителей заряда в полупроводнике. Если, например, вводятся доноры, то, как уже отмечалось, в кристаллической решетке они ионизируются с образованием свободных электронов и положительно заряженных ионов-доноров. Электроны являются значительно более подвижными частицами, поэтому они быстро диффундируют в глубь кристалла и создают электрическое поле, действующее на ионы-доноры. В результате эффективный коэффициент диффузии донорных примесных атомов возрастает. Разумеется, данный эффект заметно проявляется только тогда, когда дополнительное увеличение свободных электронов в кристалле превышает количество собственных носителей.
|
|
|
Формирование структур методом ионной имплантации
Сущность метода и отличительные особенности
Ионная имплантация – это управляемое введение примесных атомов в поверхностный слой подложки путем бомбардировки ее ионами с энергией от нескольких килоэлектрон-вольт до нескольких мегаэлектрон-вольт (обычно от 20 кэВ до 100 кэВ). Процесс ионного легирования осуществляют для модификации свойств (в первую очередь электрофизических) поверхностного слоя. Избирательность процесса легирования обеспечивается либо сканированием остросфокусированного ионного пучка по заданной программе, либо перемещением широкого ленточного пучка по предварительно маскированной поверхности.
Ионы при движении в подложке сталкиваются с атомами подложки и выбивают их из своих узлов. В результате вдоль траектории движения имплантированных ионов образуются многочисленные вакансии и междоузельные атомы, то есть создаются радиационные дефекты. Когда плотность пучка ионов превышает некоторое критическое значение, может образоваться сплошной аморфный слой. В результате столкновений ионов с атомами мишени они теряют свою энергию и, в конечном итоге, останавливаются (обычно в междоузлиях). Для того чтобы внедренные таким образом атомы смогли выполнить свои функции доноров или акцепторов, их необходимо перевести из междоузлий в узлы кристаллической решетки. Это осуществляют с помощью термического отжига. Другой важной задачей отжига является устранение возникших радиационных дефектов и восстановление исходной кристаллической структуры. Температура и продолжительность отжига определяется тем, насколько сильно нарушена кристаллическая структура подложки.
|
|
|
Метод ионного легирования имеет ряд преимуществ по сравнению с методом диффузии. Во-первых, этот метод универсален, так как с его помощью можно вводить любые примеси в любое твердое тело. Во-вторых, он обеспечивает высокую чистоту легирования, практически исключающую попадание неконтролируемых примесей в легированный слой. В-третьих, ионное легирование проводится при низких температурах (вплоть до комнатных), что позволяет использовать в качестве масок слои из фоторезиста. В-четвертых, данный метод легирования гораздо более управляем, чем метод диффузии. Изменяя плотность пучка ионов и их энергию, можно в достаточно широких пределах варьировать количество имплантированных примесных атомов и глубину их залегания.
|
|
|
Серьезным ограничением метода является малая глубина проникновения ионов в подложку и, вследствие этого, малая глубина залегания р-п-переходов. Это затрудняет выполнение последующих технологических операций и предъявляет высокие требования к качеству поверхности исходной подложки. Есть проблемы с легированием пластин большого диаметра из-за расфокусировки ионного пучка при больших отклонениях его от нормали. Радиационные дефекты хотя и устраняются в значительной степени отжигом, тем не менее оставшаяся часть может негативно сказаться на работе полупроводниковых приборов.
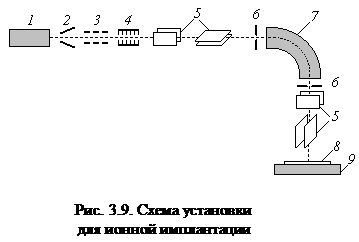 Упрощенная схема установки для ионной имплантации представлена на рис. 3.9. Цифрами на рисунке обозначены: 1 – источник ионов (газоразрядная камера); 2 – вытягивающий электрод; 3 – электромагнитная фокусирующая линза; 4 – ускоряющий электрод; 5 – отклоняющие ионный пучок пластины; 6 – входная и выходная диафрагмы; 7 – магнитный сепаратор; 8 – подложка; 9 – держатель подложки.
Упрощенная схема установки для ионной имплантации представлена на рис. 3.9. Цифрами на рисунке обозначены: 1 – источник ионов (газоразрядная камера); 2 – вытягивающий электрод; 3 – электромагнитная фокусирующая линза; 4 – ускоряющий электрод; 5 – отклоняющие ионный пучок пластины; 6 – входная и выходная диафрагмы; 7 – магнитный сепаратор; 8 – подложка; 9 – держатель подложки.
Наличие в установке для ионной имплантации магнитного сепаратора обеспечивает высокую чистоту легирования. Принцип действия сепаратора основан на взаимодействии магнитного поля, созданного в сепараторе, с движущимися ионами. В результате действия силы Лоренца ионы движутся по дуге окружности, радиус Rкоторой определяется выражением
 |
где m - масса иона; U - ускоряющее напряжение; q - заряд иона; B - магнитная индукция. Поскольку радиус кривизны траектории зависит от массы иона, то это дает возможность настроить сепаратор таким образом, чтобы через его выходную щель проходили только ионы определенной массы. Все другие ионы будут задерживаться диафрагмой и подложки не достигнут.
Физические основы метода. Распределение имплантированных ионов
Дата добавления: 2018-05-12; просмотров: 3137; Мы поможем в написании вашей работы! |

Мы поможем в написании ваших работ!
