Парофазная, жидкофазная и твердофазная эпитаксия
При парофазной эпитаксии атомы полупроводника переносятся непосредственно от источника к монокристаллической подложке без промежуточного взаимодействия путем испарения, сублимации, распыления и так далее. Количество атомов или молекул, осевших на подложке, существенно зависит от температуры подложки, состояния ее поверхности, химической природы осаждаемых атомов, их кинетической энергии и угла падения, а также других технологических факторов.
Кинетика процесса кристаллизации в значительной степени зависит от способности адсорбированных атомов мигрировать по поверхности подложки. Если бы оседающие на поверхность подложки атомы связывались с ней в точках соприкосновения, то всегда образовывался бы аморфный пористый слой вещества. Для холодной подложки так обычно и происходит. В случае нагретой подложки атомы перемещаются (мигрируют) по поверхности. Важную роль здесь играет то обстоятельство, что поверхность подложки имеет определенный потенциальный рельеф, соответствующий расположению атомов в узлах ее кристаллической решетки. Для реальной поверхности строгое чередование потенциальных барьеров и ям нарушается вследствие влияния поверхностных структурных дефектов таких, как поверхностные вакансии, адсорбированные атомы и ступеньки, обусловленные выходом на поверхность краевых или винтовых дислокаций. Обычно эти поверхностные дефекты приводят к возникновению более глубоких потенциальных ям.
|
|
|
Атомы осаждаемого вещества при столкновении с подложкой могут попадать в потенциальные ямы. В результате флуктуаций тепловой энергии (особенно при повышенных температурах подложки) они могут переходить в соседние потенциальные ямы и, таким образом, мигрировать по поверхности, а при достаточно высокой энергии повторно испаряться. Попав в более глубокую потенциальную яму, обусловленную структурным дефектом, атом устанавливает прочную связь с соседними атомами кристалла. К этому атому присоединяются другие атомы, образуется зародыш и, в конечном итоге, происходит достраивание атомной плоскости.
Таким образом, начальный этап роста эпитаксиального слоя характеризуется образованием зародышей, которые повторяют кристаллическую структуру подложки. Рост этих зародышей (увеличение их размеров) приводит к образованию островковой структуры. Островки затем сливаются, образуя сплошной эпитаксиальный слой.
Образование зародыша новой фазы сопровождается изменением свободной энергии DG, что обусловлено появлением дополнительной поверхности Sn и объема новой фазы V. В предположении сферической формы зародыша, а также отсутствия электрических полей и зарядов этот процесс можно описать уравнениями:
|
|
|
 |
 |
где r – радиус сферического зародыша; DGV - изменение свободной энергии при конденсации, практически равное энергии испарения; рпери рравн – давления перенасыщенного пара и равновесное давление пара, соответствующее температуре конденсации Т; N¯ и N - число молекул, движущихся к поверхности конденсации и испаряющихся с нее; sS – поверхностная энергия.
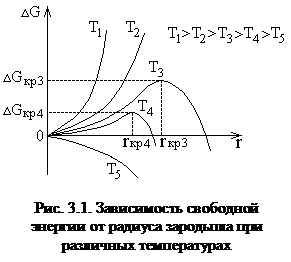 На рис. 3.1 представлены зависимости свободной энергии DGот радиуса зародыша при различных температурах. Как видно из рисунка, в некотором интервале температур зависимость DG = f(r) носит немонотонный характер. Приr < rкрсвободная энергия увеличивается, достигая значения DGкр, а при r > rкр –уменьшается. Это означает, что если размер зародыша меньше его критического размера rкр, то его рост и дальнейшее увеличение размера термодинамически невыгодно, поскольку этот процесс сопровождается увеличением свободной энергии. И только когда размер зародыша превысит критический, дальнейший рост его становится термодинамически выгодным. Агрегаты радиусом r < rкр считаются нестабильными, а агрегаты, имеющие радиус r > rкр, – стабильными зародышами новой фазы.
На рис. 3.1 представлены зависимости свободной энергии DGот радиуса зародыша при различных температурах. Как видно из рисунка, в некотором интервале температур зависимость DG = f(r) носит немонотонный характер. Приr < rкрсвободная энергия увеличивается, достигая значения DGкр, а при r > rкр –уменьшается. Это означает, что если размер зародыша меньше его критического размера rкр, то его рост и дальнейшее увеличение размера термодинамически невыгодно, поскольку этот процесс сопровождается увеличением свободной энергии. И только когда размер зародыша превысит критический, дальнейший рост его становится термодинамически выгодным. Агрегаты радиусом r < rкр считаются нестабильными, а агрегаты, имеющие радиус r > rкр, – стабильными зародышами новой фазы.
|
|
|
 |
Взяв первую производную функции DG, зависящую от радиуса зародыша, и приравняв ее нулю, можно определить rкри DGкр:
Поскольку величина DGV зависит от степени перенасыщения пара и температуры, то размер критического зародыша также должен зависеть от этих технологических параметров. Например, при малых перенасыщениях критический радиус зародыша велик, а вероятность его образования мала. Это способствует сохранению неустойчивого состояния системы. Аналогичным образом влияет и температура подложки, а именно, повышение температуры приводит к увеличению размера критического зародыша. Как видно из рис. 3.1, при достаточно высоких температурах, зародыши могут и не образоваться.
Метод жидкофазной эпитаксии заключается в выращивании монокристаллического слоя полупроводника из расплава или раствора-расплава, насыщенного полупроводниковым материалом. Полупроводник эпитаксиально кристаллизуется на поверхности подложки, погруженной в расплав, при его охлаждении. В большинстве случаев при кристаллизации из жидкой фазы в качестве растворителя используют какой-либо металл, обладающий неограниченной растворимостью с полупроводником в жидком состоянии и образующий с ним эвтектику, например, Au-Si или Al-Si. В случае жидкофазной эпитаксии полупроводниковых соединений в качестве растворителя применяют легкоплавкий компонент соединения, например, Ga для GaAs и GaP. Это позволяет снизить температуру кристаллизации и уменьшить перепад температуры на границе подложка - расплав, что повышает чистоту выращиваемого слоя.
|
|
|
При жидкофазной эпитаксии, управляемой током (электроэпитаксии), через наращиваемый эпитаксиальный слой пропускают постоянный электрический ток, тогда как температура системы «жидкость-подложка» поддерживается постоянной. При протекании тока в определенном направлении вследствие эффекта Пельтье граница раздела охлаждается, что вызывает перенасыщение раствора-расплава и процесс кристаллизации полупроводникового вещества на подложке. Таким способом удается получать качественные слои таких полупроводниковых соединений и твердых растворов, как InSb, GaAs, InP, AlGaAs.
В основе твердофазной эпитаксии лежат процессы перекристаллизации аморфного или поликристаллического слоя, нанесенного на монокристаллическую подложку. Данным методом на поверхности подложки могут быть синтезированы тонкие монокристаллические слои химических соединений. Для этого в приповерхностный слой подложки имплантируют ионы одного из компонентов, а затем проводят отжиг. Примером может служить получение слоя нитрида алюминия AlN на поверхности подложки из a-Al2O3 после имплантации в нее азота или слоя нитрида кремния Si3N4 на поверхности Si при имплантации в него тех же ионов азота.
Газофазная эпитаксия кремния
При газофазной эпитаксии атомы полупроводника переносятся к подложке в составе химического соединения. Для кремния это могут быть, например, тетрахлорид кремния SiCl4 или силан SiH4. Весь процесс можно разбить на ряд стадий: перенос реагентов к поверхности подложки; адсорбция и химическая реакция реагентов на поверхности подложки; десорбция продуктов реакции; перенос продуктов реакции от поверхности подложки к основному потоку; упорядочение адсорбированных атомов в кристаллическую решетку. Результирующая скорость роста эпитаксиального слоя определяется самой медленной стадией из приведенных выше. В равновесных условиях все процессы протекают с одинаковой скоростью и эпитаксиальный слой растет равномерно.
Среди наиболее распространенных методов формирования эпитаксиальных слоев кремния основными являются два: хлоридный и силановый. В основе хлоридного метода лежит химическая реакция восстановления кремния из тетрахлорида кремния SiCl4 водородом. Процесс осуществляют в горизонтальных или вертикальных реакторах в проточной системе. Взаимодействие тетрахлорида кремния с водородом описывается химической реакцией
SiCl4 + 2H2 ® Si + 4HCl.
Реакцию осуществляют при температурах 1000-1250 °С. Реально реакция происходит в пять стадий с образованием промежуточных продуктов SiHCl3 и SiCl2. Скорость роста эпитаксиального слоя зависит от температуры процесса и ряда других технологических факторов и обычно находится в диапазоне от 0,5 до 1,5 мкм/мин. Указанная выше реакция (точнее, все ее составляющие) обратима. Это означает, что при определенных условиях, например, когда температура реакции выходит за пределы некоторого рабочего интервала, скорость роста становится отрицательной, то есть вместо роста эпитаксиального слоя идет его травление парами HCl.
Скорость роста эпитаксиального слоя зависит от кристаллографической ориентации подложки. Она минимальна для ориентации (111). При небольших отклонениях от этой плоскости в направлении (110) скорость роста линейно увеличивается при возрастании угла отклонения, составляя примерно 5 % на один градус для температуры 1200-1250 °С. В целом ориентационная зависимость скорости роста обусловлена обратимостью реакции восстановления тетрахлорида кремния водородом.
Легирование эпитаксиального слоя в хлоридном методе осуществляют путем добавления в газ-носитель галоидных соединений легирующих примесей, например, PCl3, BCl3 или BBr3. Кроме галоидных соединений примесей могут быть использованы гидридные соединения бора, фосфора или мышьяка ( диборан В2Н6, фосфин PH3, арсин AsH3).
При получении эпитаксиальных слоев кремния наряду с целенаправленным легированием следует учитывать влияние процесса автолегирования примесями, содержащимися в подложке. Механизмы этого процесса могут быть различны: диффузия в твердой фазе из подложки в растущий слой; непосредственный перенос примесей через газовую фазу; перенос примесей в связанном виде при химическом взаимодействии компонентов парогазовой смеси с подложкой (например, при образовании летучих хлоридов примесного элемента). Наиболее существенным при высоких температурах является механизм диффузии в твердой фазе.
В основе силанового метода лежит химическая реакция пиролиза (разложения) силана:
SiH4 ® Si + 2H2.
Реакцию осуществляют при температурах 900-1100 °С. Скорость роста эпитаксиального кремния несколько выше, чем при использовании хлоридного метода и, что особенно важно, температура процесса меньше примерно на 100 °С. Поэтому процессы автолегирования в данном случае проявляются в меньшей степени. Кроме того, в меньшей степени «расплывается» скрытый слой, сформированный ранее в кремниевой подложке, так как изменение температуры на 100 °С сопровождается изменением коэффициента диффузии примесей примерно на порядок.
Из недостатков метода следует выделить большую чувствительность к качеству подложки и присутствию следов окислителя в атмосфере реактора. Кроме этого, негативное влияние оказывают гомогенные реакции над поверхностью подложки, сопровождающиеся образованием зародышей кремния, вследствие чего частицы выделившегося кремния неэпитаксиально осаждаются на подложке, ухудшая кристаллическую структуру эпитаксиального слоя. Поэтому очень важно выдерживать оптимальную температуру, чтобы максимально снизить влияние этого процесса. Силан пирофорен, то есть на воздухе самовоспламеняется. Однако при разбавлении водородом или аргоном до объемной концентрации менее 5 % он теряет способность к воспламенению.
Легирование эпитаксиальных слоев при силановом методе осуществляют путем введения в поток газовой смеси газообразных соединений примесных атомов, а именно, фосфина, арсина или диборана, разбавленных аргоном или водородом.
Молекулярно-лучевая эпитаксия
При молекулярно-лучевой эпитаксии поверхность полупроводниковой подложки в сверхвысоком вакууме (~10-9 - 10-7 Па) в строго контролируемых условиях обрабатывается нескольким молекулярными пучками одновременно, в результате чего на подложке формируется эпитаксиальный слой.
Важной особенностью молекулярно-лучевой эпитаксии является низкая скорость роста слоя, которая составляет приблизительно 1 мкм/ч или несколько моноатомных слоев в секунду. Это позволяет контролировать химический состав наращиваемого слоя и корректировать процесс по мере необходимости. По существу, молекулярно-лучевая эпитаксия позволяет «сконструировать» эпитаксиальный слой нужного химического состава и кристаллической структуры из отдельных «кирпичиков» – атомов и молекул.
Схема установки для проведения молекулярно-лучевой эпитаксии представлена на рис. 3.2. Цифрами на рисунке обозначены элементы: 1 – подложка; 2 – подогреватель подложки; 3 – источники молекулярных пучков; 4 – электронные пушки; 5 – сетка.
 Температура подложки в процессе молекулярно-лучевой эпитаксии поддерживается относительно низкой (на уровне 600-800 °С). Этого вполне достаточно, чтобы молекулы смогли мигрировать по поверхности, образуя кристаллическую решетку. В то же время процессы автолегирования, сопровождающиеся диффузией примесных атомов из подложки в эпитаксиальный слой, при таких температурах несущественны.
Температура подложки в процессе молекулярно-лучевой эпитаксии поддерживается относительно низкой (на уровне 600-800 °С). Этого вполне достаточно, чтобы молекулы смогли мигрировать по поверхности, образуя кристаллическую решетку. В то же время процессы автолегирования, сопровождающиеся диффузией примесных атомов из подложки в эпитаксиальный слой, при таких температурах несущественны.
Молекулярные пучки создаются в специальных источниках, где нужное вещество облучается электронным лучом, в результате чего формируются слабо разреженные молекулярные пучки, направляемые на подложку. Легирование эпитаксиального слоя примесными атомами осуществляется из отдельных испарителей независимо от основных молекулярных пучков. Это позволяет реализовывать самые различные профили распределения примесных атомов по глубине эпитаксиального слоя.
Наиболее важное достоинство метода молекулярно-лучевой эпитаксии состоит в том, что он позволяет с высокой точностью контролировать и корректировать параметры растущих эпитаксиальных слоев. Многие установки снабжены специальным оборудованием для химического анализа. Это, в частности, Оже-спектрометры и масс-спектрометры. Особенно хорош данный метод для получения многослойных структур с разным компонентным составом, но с близкой кристаллической структурой из полупроводниковых соединений группы А3В5 и твердых растворов на их основе. На основе таких структур (так называемых сверхрешеток) можно создавать полупроводниковые приборы с уникальными свойствами.
Гетероэпитаксия кремния на сапфире
Гетероэпитаксия кремния на изолирующих подложках является одним из перспективных направлений в технологии полупроводниковых интегральных микросхем, так как в этом случае естественным путем решается проблема изоляции элементов микросхемы друг от друга. Так, при использовании подложек из сапфира, можно почти на два порядка увеличить быстродействие микросхем за счет исключения паразитных емкостей и утечек изолирующих р-п-переходов. При этом плотность элементов и радиационная стойкость также увеличиваются.
Для гетероэпитаксиального наращивания кремния на изолирующих подложках, например, из сапфира, необходимыми условиями получения качественных слоев являются близость параметров кристаллической решетки, согласованность по коэффициенту термического расширения и отсутствие химического взаимодействия продуктов реакции с подложкой. Поэтому рассмотренный ранее хлоридный метод эпитаксии не используется, поскольку образующиеся в ходе реакции хлориды активно взаимодействуют с сапфировой подложкой.
Сапфир a-Al2O3 и кремний имеют разную кристаллическую решетку: сапфир – ромбоэдрическую, кремний – кубическую гранецентрированную. Несмотря на значительные отличия по параметрам решетки и коэффициенту термического расширения сапфир обеспечивает возможность получения однородных монокристаллических слоев кремния на достаточно большой поверхности подложки. Сапфир обладает высокой теплопроводностью при высоких диэлектрических характеристиках. Такое сочетание свойств, редкое для изоляторов, очень важно при создании ИМС с большой плотностью элементов или в производстве приборов большой мощности. Вместе с тем сапфир довольно сложно обрабатывать механически.
По поводу качества эпитаксиального слоя кремния следует отметить, что из-за рассогласования кристаллических решеток сапфира и кремния концентрация дефектов кристаллической структуры, в частности, дефектов упаковки в нем больше, чем в объемном монокристалле. Наличие структурных дефектов и вызванных ими механических напряжений вблизи границы раздела эпитаксиальный кремний – сапфир приводит к существенному снижению подвижности свободных носителей. Подвижность электронов в эпитаксиальном слое примерно на 20 % ниже, чем в объемном кристалле кремния, а для дырок это отличие достигает 50 %.
Это обстоятельство, на первый взгляд, должно было бы привести к снижению быстродействия микросхем, изготовленных на подложках из сапфира. В действительности этого не происходит. Дело в том, что в островках гетероэпитаксиального слоя формируются не биполярные транзисторы, а полевые. Современный уровень фотолитографии обеспечивает получение каналов очень малой длины. Поэтому даже при напряжении между истоком и стоком транзистора всего несколько вольт напряженность электрического поля в канале настолько велика, что дрейфовая скорость электронов достигает насыщения. Так что влияние дефектов в эпитаксиальном слое практически сведено к минимуму. Тем не менее нередко используют методы, позволяющие улучшить качество кристаллической структуры эпитаксиальных слоев. Это, в частности, достигается имплантацией в выращенный эпитаксиальный слой ионов кремния и последующей обработкой поверхности слоя лазерным лучом, что вызывает процессы рекристаллизации в эпитаксиальном слое кремния.
Дата добавления: 2018-05-12; просмотров: 1107; Мы поможем в написании вашей работы! |

Мы поможем в написании ваших работ!
