Полупроводниковые управляемые емкости (варикапы)
Содержание
Лекция 10..................................................................................................... 119
2.7. Силовые диоды.............................................................................................................. 119
2.8. Стабилитроны................................................................................................................ 120
2.9. Полупроводниковые управляемые емкости (варикапы)........................................... 121
2.10. Туннельные диоды....................................................................................................... 123
Лекция 11..................................................................................................... 126
3. БИПОЛЯРНЫЕ ТРАНЗИСТОРЫ.......................................................... 126
3.1. Принцип работы............................................................................................................ 126
Лекция 12..................................................................................................... 133
3.2. Статические вольтамперные характеристики биполярного транзистора............... 133
Лекция 13..................................................................................................... 147
3.4. Количественный анализ процессов в биполярном транзисторе.............................. 147
Лекция 14..................................................................................................... 153
3.5. Влияние конструктивно технологических характеристик транзистора на параметры эквивалентной схемы...................................................................................................................................... 153
4.5.1. Коэффициент передачи по току......................................................................... 153
4.5.4. Дифференциальное сопротивление коллекторного перехода - rк.................. 158
Лекция 15..................................................................................................... 161
3.6. Частотные характеристики биполярного транзистора.............................................. 161
3.6.1. Зависимость коэффициента передачи тока от частоты в схеме с общей базой [α(ω)]. 161
3.6.2. Зависимость коэффициента передачи тока от частоты в схеме с общим эмиттером [β(ω)].............................................................................................................................................. 163
Лекция 10
Силовые диоды
Силовые выпрямительные диоды, как правило, работают в блоках, обеспечивающих энергопитание электротехнических устройств, поэтому, как правило, они должны быть мощными, обладать высоким к.п.д. преобразования переменного тока в постоянный, не изменять свои параметры в процессе работы и их конструкция должна предусматривать хороший теплоотвод.
Поскольку на выпрямительных диодах, как правило, рассеивается значительная мощность они разогреваются, что приводит к ухудшению их выпрямительных свойств и, если температура pn перехода превысит определенное значение, диод может выйти из строя, что в свою очередь может сопровождаться выходом из строя всего силового блока.
Для характеристики воздействия температуры на pn переход вводят специальный параметр – тепловое сопротивление. Тепловое сопротивление полупроводниковых приборов характеризует как выделяющаяся в полупроводниковом приборе мощность влияет на его разогрев. Измеряется тепловое Rт сопротивление в [o/Вт] :
 (2.103)
(2.103)
Tп - температура PN перехода, Тос - температура окружающей среды
Величина Rт - зависит от конструкции прибора, в частности способа крепления кристалла, конструкции корпуса. Чем более массивный кристаллодержатель и сам корпус, тем меньше тепловое сопротивление прибора. На рис. 2.29 в качестве примера приведены конструкции двух корпусов с указанием их теплового сопротивления.

Рис. 2.29. Примеры конструкций диодов с различным сопротивлением: 1,2-малой мощности, Rт = (100-200) °/Вт,
3-средней мощности, Rт = 1-10°/Вт.
Стабилитроны
Стабилитроны полупроводниковые приборы на основе диодов с pn переходами предназначенные для работы в качестве источников опорного напряжения в различных электронных схемах.

Рис. 2.30. Диаграммы поясняющие работу стабилитрона: включение стабилитрона (а), ВАХ стабилитрона и задание его режима с помощью сопротивления R.
Для стабилизации напряжения в стабилитроне используется тот участок ВАХ диода на котором изменение тока сопровождается небольшими изменениями напряжениями. Чаще всего в стабилитроне используется участок обратимого пробоя на обратной ветви диода, соответственно pn переход в этом случае включается в обратном направлении, как это показано на рис. 2.30а.
Два встречно включенных стабилитрона могут использоваться как ограничители напряжения, которые позволяют защитить входные цепи различных устройств от перегрузок.
В тех случаях, когда требуется получить небольшие опорные напряжения для стабилизации напряжения может быть использован участок прямой ВАХ диода.
К основным характеристическим параметрам стабилитрона относят параметры характеризующие качество стабилизации напряжение в заданном диапазоне токов:
· дифференциальное сопротивление Rd=ΔUст/ΔI (обычно омы);
· температурный коэффициент напряжения выраженный в процентах относительно напряжения стабилизации Uст, он характеризует изменение напряжения стабилизации с температурой ТКН = ΔUст/(ΔTUст)%. Обычно ТКН не превышает сотых долей процента.
Полупроводниковые управляемые емкости (варикапы)
Полупроводниковые управляемые емкости- варикапы (от англ. vary – изменяться и capacitance - емкость) нашли широкое распространение в самых различных радиотехнических , телевизионных и специальных схемах для автоматической настройки контуров. В качестве варикапов используются специально сконструированные диоды, в которых емкость должна обладать высокой добротностью в заданном диапазоне частот, стабильностью во времени и по возможности мало изменяться с температурой. В варикапах pn переход включается в обратном направлении, т.е. используется его барьерная емкость.

Рис. 2.31. Эквивалентные схемы варикапа
На рис. 2.31 показаны эквивалентные схема варикапа, где R – дифференциальное сопротивление включенного в обратном направлении pn перехода, C – емкость pn перехода, rs –толщи полупроводникового материала и контактов к p и n областям. Все параметры эквивалентной схемы измеряются в заданной рабочей точке, в которой они должны быть оптимальными с точки зрения добротности варикапа.
Рассчитаем импеданс и добротность варикапа, используя эквивалентную схемы рис. 2.31а. Импеданс:
 (2.103)
(2.103)
Важнейшим параметром, определяющим качество полупроводниковой емкости, является ее добротность Q. Чем ниже активные потери в емкости, тем выше добротность. Используя (2.103) получим:
 (2.104)
(2.104)
Поскольку сопротивление перехода R в полупроводниковой емкости всегда много больше rs в (2.104) величины rs можно пренебречь, тогда:
 (2.105)
(2.105)

Рис. 2.32 Зависимость добротности варикапа от частоты (пояснения в тексте)
На рис. 2.32 показана зависимость добротности от частоты, рассчитанная по (2.105) при R=107 Ом, rs = 10 Ом и C=10 пф для кривой 1 и C=30 пф для кривой 2. Эти кривые показывают как критично значение добротности к режиму варикапа (максимальная добротность должна соответствовать рабочей частоте) и то, что при изменении смещения на варикапе будет изменяться не только его емкость (см. п.п. 2.5), но и его добротность.
Туннельные диоды
Если P и N области диода сильно легированы (до вырождения), то ширина барьерного слоя становится очень узкой и электроны могут туннелировать через него. Для изготовления туннельных диодов используют pn переход, в котором p и n области легированы до вырождения, т.е. уровень Ферми как в p, так и в n области попадает в соответствующую зону.
На рис. 2.32 показаны вольтамперные характеристики туннельных диодов, справа - обращенных. Обращенными эти диоды называются, поскольку при малых обратных смещениях у них значительно выше, чем при прямом (инверсия выпрямления). Пунктиром показаны ВАХ соответствующих диодов в случае, если бы туннельный механизм отсутствовал.

Рис. 2.32. Вольтамперные характеристики туннельных диодов.
На следующем рис. 2.33 показаны энергетические диаграммы, соответствующие различным точкам показанным на ВАХ туннельного диода рис. 2.30. Стрелками обозначены направления туннелирующих электронов (точки 2 и 3) и надбарьерный переход электронов и дырок (точка 5).
Поскольку барьер узкий при обратном смещении (т.2 на рис. 2.30 и 2.31) электроны получают возможность туннелировать из валентной зоны непосредственно в зону проводимости создавая значительный ток.
Наличие вырождения приводит к тому, что при прямом смещении электроны из зоны проводимости получают возможность туннелировать на свободные места у потолка валентной зоны p области (т.2 на рис. 2.30 и 2.31).

Рис. 2.33. Энергетические диаграммы, поясняющие работу туннельного диода.
При дальнейшем увеличении прямого смещения (т.4 на рис. 2.32) энергия дна зоны проводимости в материале n типа соответствует энергиям запрещенной зоны в материале p типа, см. энергетическую диаграмму для т. 4 на рис. 2.33, и поскольку переход на эти уровни запрещен туннельный ток падает до нуля.
Увеличение прямого смещения приводит к уменьшению высоты потенциального барьера и соответственно возрастанию надбарьерных токов (т. 5 на рис. 2.32 и рис. 2.33), как это имеет место в обычных диодах с pn переходом смещенным в прямом направлении.
Наличие на ВАХ туннельного диода участка с отрицательным дифференциальным сопротивлением (ток уменьшается при росте напряжения) позволяет на их основе создавать усилительные и генераторные схемы.
Лекция 11
БИПОЛЯРНЫЕ ТРАНЗИСТОРЫ
Принцип работы
 |
Биполярный транзистор - трехэлектродный полупроводниковый прибор с двумя, расположенными на близком расстоянии параллельными pn - переходами. Конструкции биполярного транзистора схематически показаны на рис. 3.1, там же приведены соответствующие обозначения. Как видно из рис. 3.1 транзистор состоит из трех основных областей: эмиттерной, базовой и коллекторной. К каждой из областей имеется омический контакт. Для того, чтобы транзистор обладал усилительными свойствами толщина базовой области должна быть меньше диффузионной длины неосновных носителей заряда, т.е. большая часть носителей инжектированных эмиттером должна не должна рекомбинировать по дороге к коллектору.
Рис. 3.1. Структура и обозначения pnp и npn биполярных транзисторов
На границах между p и n областям возникает область пространственного заряда, причем электрические поля в эмиттерном и коллекторном переходе направлены так, что для pnp транзистора базовая область создает энергетический барьер для дырок в эмиттерной p – области, для npn транзистора базовая область создает аналогичный барьер для электронов эмиттерной n –области. При отсутствии внешнего смещения на переходах потоки носителей заряда через переходы скомпенсированы и токи через электроды транзистора отсутствуют.
 |
Для того, чтобы транзистор работал в режиме усиления входного сигнала, эмиттерный переход смещают в прямом направлении, коллекторный в обратном, соответствующие диаграммы показаны на рис. 3.2. Приложенное к эмиттерному переходу смещение уменьшает потенциальный барьер из эмиттера в базу инжектируются дырки (в pnp транзисторе) или электроны (в npn транзисторе) инжектированные носители проходят и достигают коллектора. Между базой и коллектором барьера нет, поэтому все дошедшие до коллектора носители заряда переходят через коллекторный переход и создают коллекторный ток.
Рис. 3.2. Диаграммы, поясняющие работу биполярных транзисторов: (а) смещение на переходах отсутствует; (б) эмиттерный переход смещен в прямом направлении, коллекторный в обратном.
Поскольку коллекторный переход расположен близко от эмиттерного основная часть инжектированных эмиттером носителей достигает коллектора, таким образом инжекционный ток эмиттера примерно равен току коллектора. При этом, мощность затраченная во входной (эмиттерной) цепи, на создание тока меньше мощности, которая выделяется в выходной (коллекторной) цепи, т.е. имеет место усиление мощности. Таким образом входной сигнал изменяя высоту потенциального барьера модулирует поток неосновных носителей создающий коллекторный ток и соответственно создает усиленный за счет энергии коллекторной батареи сигнал в выходной цепи.
 |
На рис. 3.3 показаны энергетические диаграммы для pnp и npn транзисторов, соответствующие потенциальным диаграммам приведенным на рис. 32б.
Рис. 3.3. Энергетические диаграммы pnp (а) и npn (б) транзисторов в активном режиме: эмиттерный переход смещен в прямом направлении, коллекторный в обратном.
Рассмотрим токи черезколлекторный переход. Как видно из рис. 3.3а. для p-n-p транзистора вклад в управляемый ток коллектора дают инжектированные эмиттером дырки – поток 1. Электронный ток коллектора, который образуется за счет генерируемых теплом в области коллектора электронов (ток утечки, состоящий из неосновных носителей) – поток 2, не несет сигнала и жалательно, чтобы он был как можно меньще.
Для n-p-n транзистора вклад в управляемый ток коллектора дают инжектированные эмиттером электроны – поток 1 на рис. 3.3б . Дырочный ток коллектора, образуемый генерируемыми в области коллектора неосновными носителями (ток утечки) – поток 2 на рис. 3.3б, и сигнала не несет.
Рассмотрим токи через эмиттерный переход. Как видно из рис. 3.3, при прямом смещении эмиттерного перехода, помимо потока носителей инжектированных из эмиттера поток 1, возможна так же инжекция из базы в эмиттер носителей другого знака, поток 2. Этот инжекционный ток не проходит через коллекторную цепи и соответственно не способствует усилению сигнала, поэтому его стремятся сделать как можно меньше. Это достигается тем, что степень легирования эмиттера задается на значительно выше, чем степень легирования базы, тогда соответственно и инжекционный ток эмиттера выше инжекционного тока базы.
Перенос зарядов через базу транзистора можно характеризовать следующими уравнениями (для pnp транзистора):
 (3.1)
(3.1)
Коэффициент инжекции эмиттерного перехода γ показывает какая часть эмиттерного тока состоит из заряда инжектированного в базу. Поскольку только инжектированные носители создают эффект усиления желательно, чтобы коэффициент инжекции был как можно выше (обычно γ > 0,99).
Не все инжектированные эмиттером носители доходят до коллектора, некоторая их часть рекомбинирует:
 (3.2)
(3.2)
Коэффициент переноса κ показывает какая часть инжектированных носителей дошла до коллектора не прорекомбинировав. Коэффициент переноса зависит от времени жизни неосновных носителей в базе и ее длины. Именно необходимость обеспечить перенос инжектированных носителей через базу транзистора выдвигает требование, чтобы диффузионная длина была больше толщины базы транзистора Lp>>W. Выполнение этого условия позволяет обеспечить высокие значения коэффициента переноса (обычно κ > 0,98).
Коллекторный ток состоит из тока носителей заряда инжектированных эмиттером и тока утечки коллекторного перехода Iкоб (индекс б - означает, что рассматриваемая схема является схемой с общей базой - ОБ), поэтому, учитывая (4_1) и (4_2) запишем:
 (3.3)
(3.3)
Чем выше α - коэффициент передачи эмиттерного тока в коллекторную цепь, тем выше усиление транзистора по мощности, поэтому иногда этот коэффициент называют коэффициентом усиления транзистора в схеме с общей базой (рис. 51б, 52), однако этот коэффициент всегда несколько меньше единицы, если не происходит лавинного умножения носителей в коллекторном переходе. Последний эффект может иметь место при сравнительно высоких напряжениях и иногда используется в специально сконструированных транзисторах, в этом случае:
α = γκM, (3.4)
M = Iк/Ipк - коэффициент, характеризующий умножение неосновных носителей, дошедших до коллектора.
Коэффициенты γ и κ характеризуют вклад инжекционных и рекомбинационных процессов в коллекторный ток, т.е. в работу транзистора и его характеристики.
Для npn транзистора можно написать соотношения аналогичные (3.1) - (3.4), при этом изменятся только индексы обозначающие тип носителей заряда.
Запишем основные уравнения, характеризующие соотношения между токами транзистора:
Iэ = Iк + Iб,
Iк = αIэ + Iкоб. (3.5)
Для тока Iб можно написать:
Iб = Iэ - Iк = Iэ - αIэ = Iэ(1 - α) - Iкоб. (3.6)
Постоянное смещение на эмиттерном и коллекторном переходах задает некоторые значения токов и напряжений на эмиттерном и коллекторном переходах: Iэ0, Uэ0, Iк0, Uк0, которые характеризуют некоторую статическую рабочую точку на входных и выходных характеристиках. Обычно для характеристики рабочей точки используют значения в тока в выходной цепи, например для схемы рис. 3.4 это будут: Iк0, Uк0.
В усилительном каскаде для задания смещения на эмиттерный и коллекторный переходы не обязательно использовать две батареи, Для задания смещения на эмиттерный переход, как правило используется резистивный делитель, как это показано на рис. 3.4, который иллюстрирует три возможных способа задания входного сигнала относительно выходного и соответствующие эквивалентные схемы каскадов по переменному сигналу: схема с общим для входной и выходной цепей базовым электродом - ОБ, эмиттерным электродом - ОЭ и коллекторным - ОК (при составлении эквивалентных схем по переменному току сопротивление батарей принимается равным нулю).
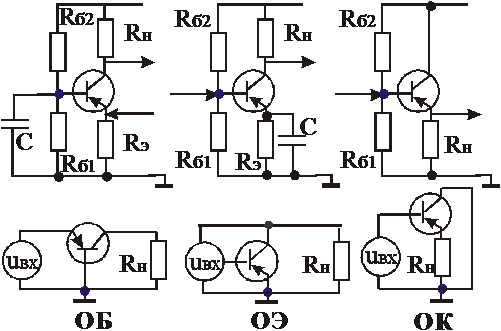 |
Рис. 3.4. Три схемы включения источника сигнала и нагрузки в усилительном каскаде и соответствующие схемы замещения каскадов по переменному току.
Сигнал от внешнего источника может сопровождаться изменением токов через электроды транзистора и напряжений на его электродах:
Iэ(t) = Iэ0 + ΔIэ(t), Uэ(t) = Uэ0 + ΔUэ(t);
Iб(t) = Iб0 + ΔIб(t), Uб(t) = Uб0 + ΔUб(t);
Iк(t) = Iк0 + ΔIк(t), Uк(t) = Uк0 + ΔUк(t).
Будем использовать для обозначения сигналов вместо приращений прописные буквы, тогда для коэффициентов передачи по току из (3.5), (3.6) для схем ОБ. ОЭ. ОК получим:
Kiб = iк/iэ = α, Kiэ = iк/iб = α./(1- α.), Kiк = iэ/iк = 1/(1-α)
Часто для коэффициента передачи тока в схеме с общим эмиттером используют значок β = Kiэ = α./(1- α.). тогда Kiк = 1/(1-α)= β+1. Коэффициент α < 1 и, как правило, составляет 0,98 - 0,99, при этом соответственно коэффициент β >> 1 и составляет 49 - 99. Таки образом для схем ОЭ и ОК имеет место усиление тока.
Лекция 12
Дата добавления: 2018-06-01; просмотров: 420; Мы поможем в написании вашей работы! |

Мы поможем в написании ваших работ!
