Методика расчета диффузионного резистора
МИНИСТЕРСТВО ОБРАЗОВАНИЯ РОССИЙСКОЙ ФЕДЕРАЦИИ
ИРКУТСКИЙ ГОСУДАРСТВЕННЫЙ ТЕХНИЧЕСКИЙ УНИВЕРСИТЕТ
РАСЧЕТ ПАССИВНЫХ ЭЛЕМЕНТОВ ИНТЕГРАЛЬНЫХ МИКРОСХЕМ
Методические указания для практических занятий
ИРКУТСК 2007
Введение
Полупроводниковая ИМС – это монолитное устройство, в котором все элементы изготовлены на единой полупроводниковой подложке и в едином технологическом цикле.
Особенность технологического процесса производства полупроводниковых ИМС заключается в том, что одновременно с изготовлением транзисторных структур необходимо получать диоды, резисторы и конденсаторы, параметры которых удовлетворяли бы требованиям, устанавливаемых на этапе схемотехнической отработки.
В гибридных интегральных микросхемах пассивные элементы выполняются по тонкопленочной или толстопленочной технологии, а активные элементы являются навесными, т.е. компонентами.
Основной задачей при проектировании всех ИМС является разработка топологического чертежа, который дает необходимую информацию непосредственно перед технологическими этапами создания микросхемы.

Рис. Фрагмент Интегральной микросхемы (ИМС)
Расчетная работа N 1
Полупроводниковые резисторы
Цель работы:рассчитать геометрические размеры окна под диффузия для получения полупроводникового резистора.
Основные теоретические сведения
|
|
|
Первоначально в полупроводниковых ИС применялись только диффузионные резисторы(ДР), основу которых составлял один из диффузионных слоев, расположенных в изолированном кармане. В настоящее время большое распространение получили также ионно-легированные резисторы.
Диффузионные резисторы. Сопротивление ДР представляет собой объемное сопротивление участка диффузионного слоя, ограниченного p-n- переходом, и зависит от геометрических размеров резистивной области и распределения примеси по глубине диффузионного слоя, которое характеризуется удельным поверхностным сопротивлением rs. Типичные значения сопротивления ДР лежат в диапазоне 4rs < R < 104rs. Нижний предел ограничен сопротивлением приконтактных областей, верхний – допустимой площадью, отводимой под диффузионный резистор. Для диффузионных резисторов чаще всего используется полоска базового слоя с двумя омическими контактами (рис. 1, а). Для такой полосковой конфигурации сопротивление ДР записывается в виде:
R=rs (l/b)
где rs— удельное сопротивление слоя , а размеры l и b показаны на рис. 1.
И длина, и ширина полоскового ДР ограничены. Длина l не может превышать размеров кристалла. Ширина b ограничена возможностями фотолитографии, боковой диффузией, а также допустимым разбросом (10-20%).
|
|
|
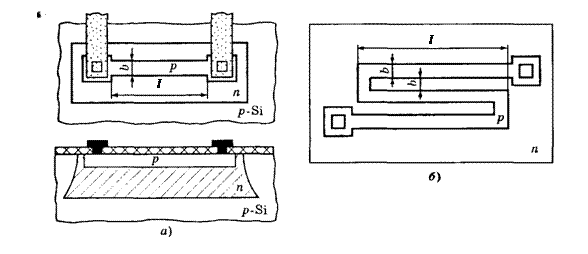
Рис. 1. Диффузионный резистор с полосковой (а) и с зигзагообразной ( б) конфигурацией.
Подставляя в формулу значения rs = 200 Ом/ и l/b = 100, получаем типичное значение максимального сопротивления Rmax = 20 кОм. Это значение можно повысить в 2-3 раза, используя не полосковую, а зигзагообразную конфигурацию ДР (рис. 1, б). В этом случае сопротивление записывается в более общем виде

Здесь п — количество «петель» (на рис. 1, б п = 2), а слагаемое 1,3 учитывает неоднородность ДР в районе омических контактов.
Количество «петель» в конечном счете ограничено площадью, отводимой под ДР. Обычно п < 3, в противном случае площадь резистора может достигать 15-20 % площади всего кристалла. Максимальное сопротивление при п = 3 не превышает 50-60 кОм.
Температурный коэффициент сопротивления ДР, выполненного на основе базового слоя, составляет 0,15-0,30 %/°С, в зависимости от значения rs. Разброс сопротивлений относительно расчетного номинала составляет ± (15-20) %. При этом сопротивления резисторов, расположенных на одном кристалле, меняются в одну и ту же сторону.
Если необходимые номиналы сопротивлений превышают 50-60 кОм, можно использовать так называемые пинч-резисторы. Структура пинч-резистора показана на рис. 2. По сравнению с простейшим ДР пинч-резистор имеет меньшую площадь сечения и большее удельное сопротивление (так как используется донная, т.е. слабо легированная часть р-слоя). Поэтому у пинч-резисторов удельное сопротивление слоя обычно составляет 2-5 кОм/ и более, в зависимости от толщины. При таком значении rsмаксимальное сопротивление может достигать значений 200—300 кОм даже при простейшей полосковой конфигурации.
|
|
|
Недостатками пинч-резисторов являются: больший разброс номиналов (до 50 %) из-за сильного влияния изменения толщины р-слоя, больший температурный коэффициент сопротивления (0,3-0,5 %/°С) из-за меньшей степени легирования донной части р-слоя, нелинейность вольт-амперной характеристики при напряжениях более 1—1,5 В. Пробивное напряжение пинч-резисторов определяется пробивным напряжением эмиттерного перехода (обычно 5-7 В).
Если необходимые номиналы сопротивлений составляют 100 Ом и менее, то использование базового слоя в ДР нецелесообразно. Для получения ДР с малыми номиналами сопротивлений используют низкоомный эмиттерный слой. При значениях rs = 5-15 Ом/, свойственных этому слою (см. табл. 1), удается получить минимальные сопротивления 3-5 Ом с температурным коэффициентом 0,01-0,02 %/°С.
|
|
|
Ионно-легированные резисторы. За последнее время все большее распространение получают ионно-легированные резисторы, которые в отличие от ДР получаются не диффузией, а локальной ионной имплантацией примеси.
Структура ионно-легированного резистора такая же, как ДР (рис. 3), но глубина имплантированного р-слоя значительно меньше глубины базового слоя и составляет всего 0,2-0,3 мкм. Кроме того, ионная имплантация позволяет обеспечить сколь угодно малую концентрацию примеси в слое. Оба фактора способствуют получению весьма высоких удельных сопротивлений слоя — до 10—20 кОм/. При этом номиналы сопротивлений могут составлять сотни килоом. ТКС меньше, чем у ДР, и лежит в пределах 3-5%/°С, а разброс сопротивлений не превышает ±(5-10)%.
Поскольку толщина имплантированного слоя мала, к нему трудно осуществить омические контакты. Поэтому по краям резистивного слоя на этапе базовой диффузии осуществляют узкие диффузионные р-слои, к которым омический контакт осуществляется обычным способом.
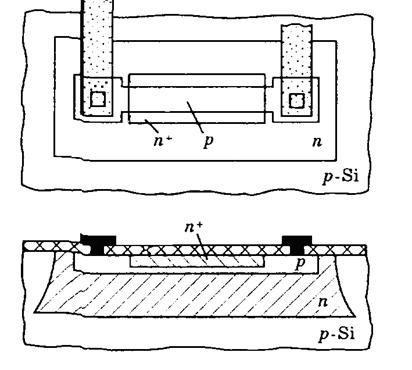
Рис. 2. Пинч-резистор

Рис. 3. Ионно-легированный резистор
Эквивалентные схемы. Характерной особенностью любого интегрального резистора является наличие у него паразитной емкости относительно подложки или изолирующего кармана. В простейшем ДР (рис. 1) такой паразитной емкостью является барьерная емкость перехода между рабочим р-слоем и эпитаксиальным n-слоем кармана .
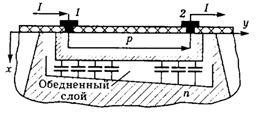 Строго говоря, совокупность резистора и паразитной емкости представляет собой распределенную LС-линию (рис.4).
Строго говоря, совокупность резистора и паразитной емкости представляет собой распределенную LС-линию (рис.4).
Однако для приближенных расчетов удобнее пользоваться эквивалентными схемами: П-образной (рис. 5, а) или Т-образной (рис. 5, б).
Рис. 4 Физическая модель
интегрального резистора в виде
распределенной RC-линии.

Рис.5 Эквивалентные схемы интегрального резистора
На этих схемах R — сопротивление,  - усредненная емкость перехода.
- усредненная емкость перехода.
Необходимость усреднения емкости объясняется следующим. При протекании тока через резистор потенциал р-слоя оказывается разным в разных точках. Поскольку потенциал n-слоя постоянный, напряжение на p-n-переходе будет меняться вдоль оси у, а следовательно, будет меняться и барьерная емкость.
В типичном случае, когда один из зажимов резистора (например, 2) находится под постоянным потенциалом, а через другой зажим (1)задается ступенька тока, эквивалентная П-образная схема сводится к простейшей RС-цепочке, показанной на рис. 5, в. Сущность переходного процесса состоит в плавном изменении напряжения на резисторе при скачкообразном изменении тока. Постоянная времени, определяющая длительность переходного процесса, имеет вид  ,
,
соответствующая граничная частота

Для значений R = 10 кОм и  = 1,3 пФ получаем: τ = 6,5 нc и fгр ≈ 25 МГц. Это значит, что в данном примере резистор выполняет свою функцию (т.е. имеет чисто активное сопротивление) только до частот 10-15 МГц. При более высоких частотах его сопротивление становится комплексным и работа схемы, в которой он используется, может существенно измениться.
= 1,3 пФ получаем: τ = 6,5 нc и fгр ≈ 25 МГц. Это значит, что в данном примере резистор выполняет свою функцию (т.е. имеет чисто активное сопротивление) только до частот 10-15 МГц. При более высоких частотах его сопротивление становится комплексным и работа схемы, в которой он используется, может существенно измениться.
Рассмотренные эквивалентные схемы действительны и для других вариантов резисторов: когда рабочими являются эмиттерный или коллекторный слой, а также при диэлектрической изоляции элементов. Однако количественные результаты оказываются разными. Например, при использовании диэлектрической изоляции постоянная времени может быть в несколько раз меньше.
Топология интегральных резисторов представлена на рисунке 6. Низкоомные резисторы (десятки Ом) имеют малое отношение длины к ширине резистора. Резисторы с сопротивлением от сотен Ом до единиц кОм имеют вид, изображенный на рисунке 6,а. Для высокоомных резисторов (до 20 кОм) применяют резисторы, топология которых показана на рисунке 6,б.Резисторы с сопротивлением до 60 кОм имеют форму меандра (рис. 6,в).
|

Методика расчета диффузионного резистора
При создании ИМС параметры ДР регулируют выборомконфигурации и геометрических размеров резисторов. Исходными данными для расчета геометрических размеров резисторов являются: номинальное значение сопротивления R с допустимой относительной погрешностью g =DR/R (20 %) ; удельное поверхностное сопротивление материала резистора rs; ( для базового слоя 200 Ом/, для эмиттерного слоя 10 Ом/, для ионно-легированного 1000 Ом/); значения мощности рассеяния Р (0,1 Вт); максимальная рабочая температура Tmax(40° С); минимальная рабочая температура Tmin (-40° С).
Толщина базового слоя 3 мкм, толщина эмиттерного слоя 2 мкм.
Расчет геометрических размеров резистора начинают с определения его ширины b, а затем длины l .
За расчетную ширину резистора bрасч принимают значение, которое не меньше наибольшего значения одной из величин:
bрасч = max{ bтехн., bточн , bр},
где bтехн.- минимальная ширина резистора, определяемая разрешающей способностью технологических процессов; bточн - минимальная ширина резистора, при которой обеспечивается заданная погрешность размеров ; bр - минимальная ширина резистора, определяемая из максимально допустимой мощности рассеяния. bтехн находят из перечня технологических ограничений (bтехн » 5мкм), bточн - определяется из выражения:
bточн = (Db+Dl/Kф) / g  ,
,
где Db и Dl – абсолютные погрешности ширины и длины резистивной полоски, обусловленные технологическими процессами (Db = Dl » 0,1мкм ); коэффициент формы Kф = l / b = R / rs; погрешность коэффициента формы g  =DKф /Kф= DR/R – Drs/rs - aR DT, здесь DR/R = g (допустимая относительная погрешность), для базового слоя 20%; Drs/rs=grs (относительная погрешность воспроизведения удельного поверхностного сопротивления, для практических расчетов 5%); aR DT – температурная погрешность сопротивления, aR=0,5*10-3 1/град; DT=Tmax- T
=DKф /Kф= DR/R – Drs/rs - aR DT, здесь DR/R = g (допустимая относительная погрешность), для базового слоя 20%; Drs/rs=grs (относительная погрешность воспроизведения удельного поверхностного сопротивления, для практических расчетов 5%); aR DT – температурная погрешность сопротивления, aR=0,5*10-3 1/град; DT=Tmax- T  .
.
bр - минимальная ширина резистора, определяемая из максимально допустимой мощности рассеяния:
bр=  ,
,
где Ро- максимальная удельная мощность рассеяния (для кремния Ро= 5,0 Вт/мм2).
Дата добавления: 2018-05-31; просмотров: 2231; Мы поможем в написании вашей работы! |

Мы поможем в написании ваших работ!
