Маскирующие покрытия при анизотропном травлении
Маскирующим материалом при анизотропном травлении являются пленки SiO2. Устойчивость пленки SiO2 в щелочном растворе зависит от концентрации КОН. Превышение 40%-ной концентрации травителя приводит к резкому увеличению скорости травления диоксида кремния, а при стравливании последнего – к потере четкого микрорельефа на подложке. Для правильного выбора толщины пленки оксида необходимо знать некоторое критическое значение толщины пленки SiO2. При оптимальной концентрации щелочного травителя (КОН : Н2О) скорость травления SiO2 0,01; Si {100} 3,2; Si {110} 4 мкм/мин.
Щелочные травители воздействуют на маски из алюминия. Практически не травятся в щелочи пленки нитрида кремния. При травлении сквозных отверстий в толстых пластинах кремния (500мкм) в качестве маски используют Si2N4 толщиной около 0,1 мкм. Аминопирокатехиновые смеси позволяют использовать в качестве масок не только диоксид кремния, но и ряд металлов Al, Ag, Au, Cu и др.
Качество вытравливаемого рельефа
Процесс травления кремния оценивают по скорости травления плоскости (100) или (110), качеству поверхности боковых стенок и дна, угловому и боковому подтравливаниям, которые зависят от состава травителей, температуры травления и времени. На качество поверхности дна с ориентацией (100) влияют: образование четырехгранных пирамидок с боковыми гранями (111); образование волнообразной поверхности (рис. 4).
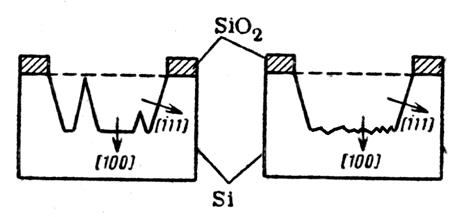
Рис. 4. Дефекты на дне (100) V-канавки.
|
|
|
Появление пирамидок обусловлено дефектами на поверхности исходного материала, которые травятся с меньшей скоростью по сравнению с плоскостью (100), а также химической реакцией процесса анизотропного травления, сопровождающейся образованием диоксида кремния с последующим его разложением, что приводит к образованию бугорков.
Нарушения волнообразного типа на поверхности (100) могут возникать, когда не принимаются меры к предотвращению неоднородности состава травителя. Это явление имеет место при недостаточном просушивании пластин кремния перед анизотропным травлением, а также при плохом перемешивании раствора. Поэтому перед травлением пластины должны быть тщательно очищены и высушены.
При локальном анизотропном травлении кремния особо остро стоит вопрос об искажении формы элементов на фотошаблоне. Различают боковое и угловое растравливание заданного рельефа. Уменьшение растравливания достигается подбором состава травителя, точной ориентацией рисунка относительно выбранного кристаллографического направления. Для кремния ориентации (100) геометрия окна вытравливаемого в пластине должна быть прямоугольной или квадратной, стороны должны быть ориентированы параллельно или перпендикулярно направлению [110]. Для кремния (110) рисунок должен быть шестиугольным (ромб, параллелограмм), стороны которого должны располагаться параллельно или под углом 70° к направлению [111].
|
|
|
При ориентации исходной пластины (110) и направлении рисунка изолирующих областей параллельно плоскостям {111} можно получить канавки с вертикальными стенками при очень малом растравливании (скорость бокового растравливания не превышает 3% от скорости травления в глубину).
Разориентация окна в оксидной маске сопровождается увеличением размера вытравливаемой лунки в подложке Si. Растворение кремния продолжается до тех пор, пока фронт травления не достигнет ближайших {111} плоскостей, ограняющих окно.
Следует отметить, что геометрия поверхности, создаваемой изотропным травлением, будет зависеть от геометрии первоначальной поверхности.
Состав травителей
Химическое травление полупроводников основано на процессах окисления поверхности и удаления образовавшихся продуктов. В состав травителей обычно включаются:
1) растворитель;
2) окислитель, который обеспечивает образование окисла на поверхности кремния, основными окислителями в кислотных травящих растворах для кремния являются HNO3 и H2O2;
|
|
|
3) комплексообразователь, который в результате взаимодействия с диоксидом кремния образует растворимое соединение. К комплексообразователям относятся, например, такие кислоты как HF и HCl;
4) ускорители или замедлители первых двух реакций, если последние протекают с такой скоростью, что ими трудно управлять (например, Br2);
5) замедлитель реакции травления. Чаще всего для этого используют ледяную уксусную кислоту (CH3COOH) или воду. Следует отметить, что разбавление травителя водой может иногда привести к выявлению структурных дефектов.
6) специальные добавки, обусловливающие селективность действия травителя.
Наиболее распространенными травителями для кремния являются смеси на основе азотной и плавиковой кислот. Для получения с их помощью однозначных результатов требуется чрезвычайно тщательная очистка поверхности; кроме того, необходимо следить, чтобы в процессе травления поверхность не приходила в контакт с воздухом. Основные составы травителей и режимы травления представлены в таблице 2.
Таблица 2.
Составы травителей и режимы травления.
| № п.п | Состав травителя | Режимы травления | ||
| Смеси на основе азотной и плавиковой кислот
| ||||
| 1 | Травитель Уайта: 3ч.HNO3+1ч.HF | Полирующий травитель. Травление поверхности (111) | ||
| 2 | Травитель Деша: 1ч.HF+3ч.HNO3+10ч.CH3COOH | Травление всех плоскостей. Образование глубоких ямок, проходящих вдоль дислокационных линий внутрь кристалла. | ||
| 3 | 40мл HF+35млHNO3+25млH2O+ +10млCH3COOH+1гCu(NO3)23H2O | Травление всех плоскостей. Образо-вание глубоких ямок, проходящих вдоль дислокационных линий внутрь кристалла. | ||
| 4 | Травитель CP-4A: 3ч.HF+5ч.HNO3+3ч. CH3COOH | Медленное химическое полирование. | ||
| 5 | 8ч.40-42%-ной HF+ +10ч.56-57%-нойHNO3+10ч.CH3COOH | Плоскости (111), (110) и (100). | ||
| 6 | 10ч. 40-42%-ной HF+ +10ч. 56-57%-ной HNO3+ +20ч. CH3COOH+3ч. Br2 | Плоскости (111), (110) и (100). | ||
| 7 | Медный травитель: 4млHF+2млHNO3+ +4млH2O+0.2гCu(NO3)2 3H2O | Плоскости (111), (110) и (100). | ||
| 8 | 5ч. медного травителя + 3ч.CP-4 | Плоскости (111), (110) и (100). | ||
| 9 | 10г 47-49%-ной HF+ +5г 70-71%-ной HNO3+14гCH3COOH | Полирующий травитель | ||
| 10 | 600±6млHF+ +300±3млHNO3+ +28±0.3гCu(NO3)2 3 H2O | Дислокационный травитель. | ||
| Травители на основе хромовой и плавиковой кислот | ||||
| 11 | 1.Основной раствор: 50г CrO3+100млH2O 2.Основной раствор перемешивают с 38-40%-ной HF в отношении 2:1 для больших, 1:1 для средних и 2:3 для небольших ямок травления (высокая плотность дислокаций) | Образование ямок травления на плоскости (111) | ||
| 12 | 1ч. водного раствора CrO3 (2ч. H2O+1ч. CrO3)+1ч. HF | Химическая полировка | ||
| Продолжение табл.2. | ||||
| 13 | 1ч. HF+1ч.H2CrO4 | |||
|
«Окрашивающие» травители | ||||
| 14 | 100ч. HF +0.1-0.5 ч. HNO3 | Выявление p-n-перехода. Материал p-типа темнеет больше, чем n-типа | ||
| 15 | 50мл разбавленного раствора Cu(NO3)2+1-2 капли HF | Выявление p-n-перехода. Медь осаждается на материале n-типа (на участках с более низким удельным сопротивлением осаждение происходит интенсивнее) | ||
| Методы анодного травления | ||||
| 16 | 1ч. 48%-ной HF+1ч. CH3COOH (лед) | Образование фигур травления на кристаллах Si n-типа. | ||
| Щелочные травители | ||||
| 17 | 1-30 %-ный раствор NaOH или KOH | Быстро выявляются детали структуры, особенно хорошо – двойниковые ламели на плоскости (111) | ||
| 18 | 4%-ный NaOH. К раствору добавляют 40%-ный NaOCl до тех пор, пока на кремнии не прекратится выделение водорода | Для утонения образцов при электронной микроскопии | ||
Дата добавления: 2020-12-12; просмотров: 156; Мы поможем в написании вашей работы! |

Мы поможем в написании ваших работ!
